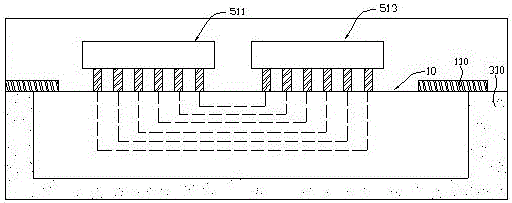
本实用新型涉及一种封装基板的结构,属于半导体封装技术领域。
背景技术:
电子产品日益小型化、轻便化、多功能、低功耗及低成本发展趋势,2D(二维)封装技术已经无法满足要求,部分产品已经开始向2.5D或3D封装方向发展。而在2.5D或3D封装结构中,硅基转接板与有机基板的结合使用,是实现芯片与芯片、芯片与基板互连的重要途径。
传统TSV 转接基板制作工艺为:1)在基板上制备盲孔;2)基板单面PECVD 淀积通孔侧壁钝化层;3)在基板单面磁控溅射淀积通孔侧壁黏附/ 扩散阻挡层、种子层金属;4)电镀工艺完成通孔金属填充;5)通孔金属平坦化;6)减薄露出基板背面通孔金属;7)制作金属布线、焊盘及其保护层。
传统TSV 转接基板制备方法还有以下缺陷或不足:
(1)PECVD 淀积深孔侧壁钝化层均匀性差,深孔底部绝缘层厚度大约只有顶部的1/5,底部绝缘层覆盖率较差,容易产生不连续缺陷而严重影响绝缘效果和可靠性。这也限制了钝化层淀积工艺深宽比淀积能力;
(2)磁控溅射淀积深孔侧壁粘附/ 扩散阻挡层、种子层均匀性差,深孔底部厚度大约只有顶部的1/5,深孔底部覆盖率较差,容易产生不连续缺陷而导致电镀时出现空洞,严重影响通孔可靠性。目前,最先进的磁控溅射设备的深孔深宽比淀积能力小于15:1,这限制了TSV 深宽比淀积能力;
(3)深宽比为20:1 ~ 30:1 的深孔,实现无孔洞电镀填充工艺难度较大,而大孔径将占据元件组装面积、减小布线面积,不利于高密度封装;
(4)限于上述传统TSV 转接基板制作工艺,通常转接基板厚度小于200μm,仅可用作转接基板,无法与整机板直接进行组装;
(5)TSV转接板工艺成本较高,且封装工艺复杂,在诸多封装技术中不具备成本优势;
(6)TSV转接板因硅与有机基板材料存在物性差异,埋入到有机基板中存在可靠性问题,难以进行结构整合;
(7)普通有机基板可满足一般密度封装要求,但无法实现超高密度(如低于55um间距凸点倒装)封装要求。
技术实现要素:
承上所示,本实用新型的目的在于克服上述传统有机基板与TSV转接板技术的不足,提供一种同时具备超高密度结构和普通密度封装结构的混合密度有机基板结构。
本实用新型的目的是这样实现的:
本实用新型的目的是这样实现的:
一种封装基板的结构,其包括普通基板,所述普通基板的上表面设有若干个焊盘Ⅰ、下表面设有若干个焊盘Ⅱ,
还包括超高密度基板、高密度芯片、低密度芯片和包封层Ⅰ,所述包封层Ⅰ设置于普通基板的上表面,所述超高密度基板由若干层高密度再布线金属层和选择性间隔于其间的绝缘层构成,且其上表面设置焊盘,两层或两层以上所述高密度再布线金属层彼此之间存在选择性电性连接,所述超高密度基板嵌于包封层Ⅰ内且其上表面及其焊盘露出包封层Ⅰ,所述超高密度基板的上表面的部分焊盘与所述高密度芯片倒装连接,在所述高密度芯片的垂直区域外形成若干个基板外层金属电极,部分所述基板外层金属电极的上表面与所述低密度芯片倒装连接、其下表面通过穿透包封层Ⅰ的盲孔及其盲孔内金属与普通基板的部分焊盘Ⅰ连接,部分所述基板外层金属电极的下表面与超高密度基板的部分焊盘连接,所述焊盘Ⅱ设置焊料凸块。
本实用新型所述超高密度基板的高密度再布线金属层的线宽/线距为6/6um以下。
可选地,所述超高密度基板的高密度再布线金属层的线宽/线距为5/5um、3/3um或1.8/1.8um。
本实用新型所述超高密度基板的高密度再布线金属层的层数为5层以上。
可选地,所述超高密度基板的高密度再布线金属层的层数为6层、7层、8层。
本实用新型还包括包封层Ⅱ,所述包封层Ⅱ覆盖高密度芯片、低密度芯片和高密度基板、包封层Ⅰ、基板外层金属电极的裸露部分。
可选地,还包括通孔,所述通孔穿透包封层Ⅰ和普通基板,其内填充金属,部分所述基板外层金属电极的下表面通过通孔内金属与普通基板的部分焊盘Ⅱ连接。
本实用新型的有益效果是:
1、本实用新型的混合密度封装基板结构通过引用超高密度有机基板代替Si Interposer,并嵌入至普通的有机基板结构中,提供更小的线宽/线距、更多的高密度再布线金属层的层数,在同等封装面积内集成封装多个高密度芯片和低密度芯片,不仅可以有效缩短信息传输路径,而且可以实现更多功能、更高功率,实现更多引出端,有利于信号更快地传输,以适应半导体IC元件在高速、高频及大容量化等性能方面的快速提高,同时还进一步减小了整体的封装厚度,以适应许多高性能但受空间影响的应用器件,是一种具有高成本效益与灵活性的封装技术;
2、本实用新型充分利用了超高密度基板的柔性特点,提升了封装可靠性,有利于产品良率的提升。
附图说明
图1为本实用新型一种封装基板的封装结构的实施例的剖面示意图;
图2为图1局部放大的示意图;
其中:
超高密度基板10
基板外层金属电极110
盲孔150
通孔170
普通基板20
焊盘Ⅰ230
焊盘Ⅱ250
焊球251
包封层Ⅰ310
包封层Ⅱ430
高密度芯片51
低密度芯片53
包封层Ⅱ610。
具体实施方式
实施例
普通基板20一般是指制造电子封装基板、制造搭载电子元器件的母板的基础材料。其具有导电、绝缘和支撑三个方面的功能,一般情况下,基板就是覆铜箔层压板,通过有选择地进行孔加工、化学镀铜、电镀铜、蚀刻等加工,在基板上得到所需电路图形,并在普通基板20的上表面形成若干个焊盘Ⅰ230、下表面形成若干个焊盘Ⅱ250,如图1所示。一般地,普通基板20的金属层的线宽/线距为40/40um、20/20um、8/8um,极限情况能做到线宽/线距10/10um。本实用新型的封装基板的结构,其在普通基板20的上方设置具有柔性特点的超高密度基板10。该超高密度基板10由数层高密度再布线金属层和选择性间隔于其间的绝缘层构成,两层或两层以上的高密度再布线金属层彼此之间存在选择性电性连接,并于超高密度基板10的上表面设置焊盘,其具备轻、薄、耐摔及形状可塑性高等柔性特点。利用再布线金属工艺,超高密度基板10的高密度再布线金属层的线宽/线距为6/6um以下,线宽/线距一般在(3-5)/(3-5)um,线宽/线距最小能达到1/1um。其金属布线层数在3层以上,一般为4-6层,最多可以达8层。线宽/线距与层数可依据具体产品设计进行详细定义。在高密度再布线金属层的线宽/线距在6/6um以下,如线宽/线距为5/5um、3/3um、1.8/1.8um等,随着高密度再布线金属层的层数的增加,其工艺难度呈跳跃式递增。由此可知,与普通基板20相比,超高密度基板10的线宽/线距更小、高密度再布线金属层的层数更多,单位面积再布线金属层更密,故称之为超高密度基板10,其总厚度不超过100um,有利于减小整体的封装厚度。同时,超高密度基板10的具有柔性特点,可以提升混合密度封装基板的整体可靠性。
普通基板20的上表面设置包封层Ⅰ310,将该超高密度基板10嵌于包封层Ⅰ310内且其上表面及其焊盘露出包封层Ⅰ310。该包封层Ⅰ310的材料可以使用有机基板行业的普通包封薄膜材料,包括但不限于环氧类包封树脂,如ABF膜。
超高密度基板10的上表面的部分焊盘与高密度芯片51倒装连接。高密度芯片51通常指R、C、L等应用于要求高精度、尺寸小的无源元件,其封装特点是其芯片金属凸点个数多、芯片金属凸点彼此之间的间距小。高密度芯片51的个数可以单个,也可以多个,如图1所示,高密度芯片511、高密度芯片513的型号可以相同,也可以不同。
在高密度芯片51的垂直区域外形成若干个基板外层金属电极110,基板外层金属电极110的上表面与低密度芯片53倒装连接。低密度芯片53是指其芯片金属凸点个数不多、芯片金属凸点彼此之间的间距不小的芯片。基板外层金属电极110的上表面与低密度芯片53连接。如图1所示,低密度芯片535与基板外层金属电极110的上表面贴装连接,低密度芯片537通过焊球与基板外层金属电极110的上表面倒装连接。
基板外层金属电极110的下表面通过穿透包封层Ⅰ310的盲孔150及其盲孔内金属与普通基板20的部分焊盘Ⅰ230连接,或根据实际需要,使部分基板外层金属电极110的下表面通过穿透包封层Ⅰ310和普通基板20的通孔170及其通孔内金属与普通基板20的部分焊盘Ⅱ250连接。部分基板外层金属电极110的下表面与超高密度基板10的部分焊盘连接。
材料包括但不限于ABF膜的包封料覆盖高密度芯片51、低密度芯片53和高密度基板10、包封层Ⅰ310、基板外层金属电极110的裸露部分,形成包封层Ⅱ610。包封层Ⅱ610的材质与包封层Ⅰ310的材质可以是相同的,也可以不同。
焊盘Ⅱ250处可以设置焊球251、焊块等焊料凸块,将整个封装结构的电信息进行输入输出。
本实用新型的封装基板的封装结构,运用超高密度基板10可以减薄封装基板的整体封装厚度,避免了传统封装结构存在的TSV深孔所带来的一系列缺陷和工艺问题;同时,整体封装厚度的减小,以适应许多高性能但受空间影响的应用器件,是一种具有高成本效益与灵活性的封装技术。
在使用的时候,高密度芯片511与高密度芯片513的电信号在超高密度基板10的内部进行交流。或者高密度芯片51通过基板外层金属电极110、盲孔150及其盲孔内金属与普通基板20实现电性连接。低密度芯片53可以通过基板外层金属电极110、盲孔150及其盲孔内金属或者通过通孔170及其通孔内金属与普通基板20实现电性连接。
本实用新型通过运用超高密度基板10可以减薄封装基板的整体封装厚度,避免了传统封装结构存在的TSV深孔所带来的一系列缺陷和工艺问题;同时,整体封装厚度的减小,以适应许多高性能但受空间影响的应用器件,是一种具有高成本效益与灵活性的封装技术。
本实用新型的封装基板采用圆片级加工工艺,不需采用繁琐复杂的TSV工艺、避免了深孔电镀工艺等一系列问题,降低了生产成本,提高了生产效率,而应用具有柔性的超高密度基板10提升了封装可靠性,有利于产品良率的提升。
需要指出的是,熟悉该领域的技术人员对本实用新型的具体实施方式所做的任何改动均不脱离本实用新型的权利要求书的范围。相应地,本实用新型的权利要求的范围也并不仅仅局限于前述具体实施方式。
文章来自(www.ipcb.cn)爱彼电路是专业高精密PCB电路板研发生产厂家,可批量生产4-46层pcb板,电路板,线路板,高频板,高速板,HDI板,pcb线路板,高频高速板,IC封装载板,半导体测试板,多层线路板,hdi电路板,混压电路板,高频电路板,软硬结合板等。