Mole定律作为电子制作产业链的金科玉律,一直矗立于科学技术进展的最前沿,给整个儿电子制作产业链指清楚十分清楚的趋势,可以说厚泽万物。但近些年,因为IC制作过程中运用的光刻技(Photolithography)相对于Mole定律显得相对落后,IC业界给与厚望的EUV(Extreme UltraViolet)光刻设施也在紧锣密鼓的开发中,技术成熟度尚达不到量产的水准,要得IC制导致本在晶圆节点(Wafer Node)不断由大变小的事情状况下,成本闪现指数提高;另一方面,2017年,水果A11/A10X、高通骁龙835、三星Exynos 8895、华为Kirin970和联发科Helio X30蓄势待发,晶圆节点已经进展到10nm量产的阶段,已经十分靠近FinFET制程的物理极限5nm,也即即使EUV光刻设施可以量产运用,也没有办法变更Mole定律将要失去生命的发展方向。那接下来电子制作行业该何去何从?业界和教育界也给出了比Mole定律更为多元化的解答:more moore(深度Mole,IC制作角度的Mole定律)和more than moore(逾越Mole,IC封装角度的Mole定律),见图1:
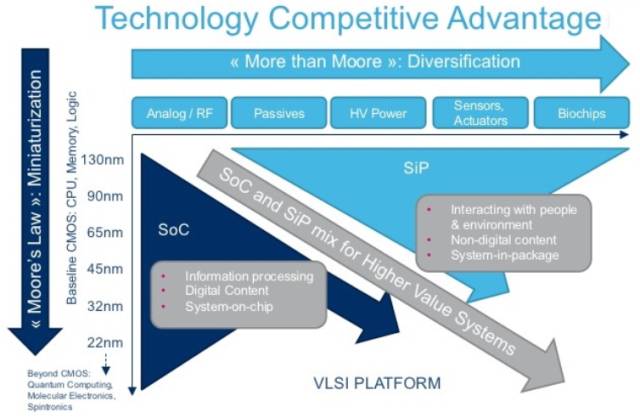
图 1 后Mole定律时期Roadmap
何谓深度Mole(more moore,IC制作角度的Mole定律),是延长下去CMOS(FinFET)的群体思考的线索,在部件结构、沟道材料、连署导线、高媒介金属栅、架构系统、制作工艺等等方面施行创新开发,沿着Mole定律一路scaling(每两到三年左右,结晶体管的数量翻倍),见图2 Logic IC的roadmap:
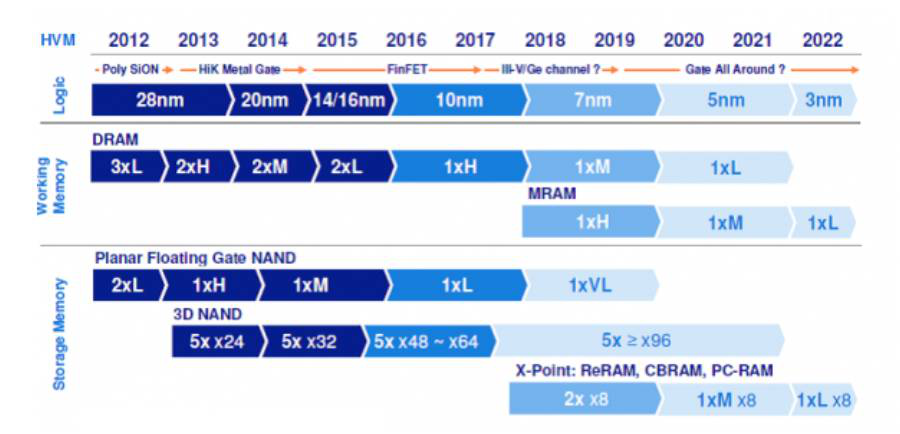
图 2 Wafer Node Roadmap
到现在为止深度Mole普通适合使用于数码电路,如智强手机中的处置器(AP)和基带芯片(Base Band),均归属SoC的范畴。面前我们也提到,因为FinFET的物理极限是5nm,那末进展到5nm后怎么样接着呢?那就务必突破FinFET的结构和材料限止,研发和研讨新的Transistor(switch)方式,如Tunneling FET(TFET)、Quantum Cellular Automata (QCA) 、SpinFET等,也即图1中所说的的Beyond CMOS。
何谓逾越Mole(more than moore,IC封装角度的Mole定律),主要偏重于功能的多样化,是由应用需要驱动的。之前集成电路产业一直延长下去Mole定律而飞速进展,满意了同一段时间许多人对计算、储存的迫切地盼望与需要。但芯片系统性能的提高不再靠天真的暴力结晶体管scaling,而是更多地有赖电路预设以及系统算法优化,同时集成度的增长不尽然要靠暴力地把更多板块放到同一块芯片上,而是可以靠封装技术来成功实现集成。摹拟/射频/混合信号板块等不必最先进工艺的板块可以用较成熟且价格低廉的工艺成功实现(譬如为摹拟射频工程师所喜闻乐见的65nm),而数码板块则可以由先进工艺成功实现,不一样板块可以用封装技术集成在同一封装中,而板块间的通讯则运用高速接口。这种集成形式即异质集成(heterogeneous integration),是到现在为止在工业界和教育界都十分火的SiP,不惟可以降低成本,并且可以更加集成化,见图3(b)。智强手机中的射频前端板块、WiFi板块、蓝牙板块和NFC板块等摹拟电路均适合使用于逾越Mole的情形。
回头再看Mole定律的两个方向,不过就是SoC和SiP的差别,一个是IC预设角度,一个是IC封装角度,见图3,也可是数码电路与摹拟电路的差别。这么,再去了解SoC和SiP何其简单。
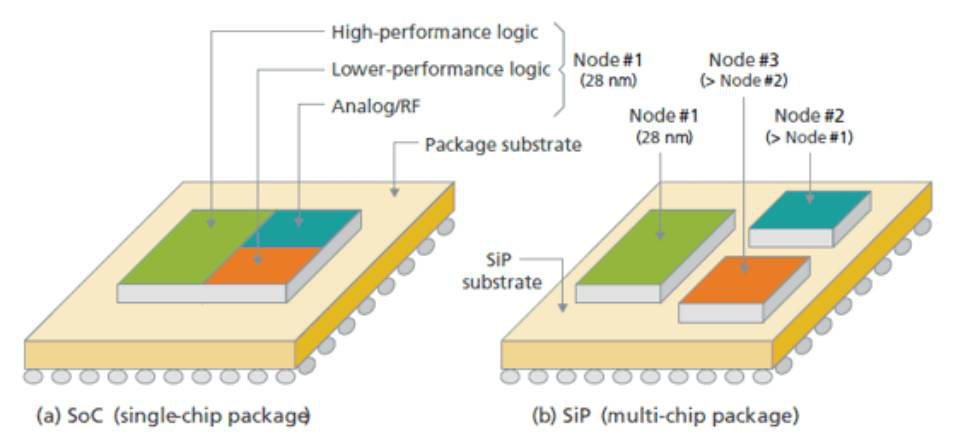
图 3 SoC与SiP
那我们再把眼看东西假想线从理论预先推测转向实际应用,作为消费电子时期的弄潮儿水果企业天然是大家商议技术走向的焦点。随着水果企业宣布iPhone 10周年的靠近,记念版iPhone的消息儿更是络绎不绝,让人目没时间接,其最新技术走向更是值当大家剖析悬揣。
首先就是2016年九月iPhone 7的A10 Fusion第一次认为合适而使用TSMC 16nm 的InFoWLP封装技术,绝对代替了过去的FCCSP的封装技术,而说话时的这一年九月将要宣布的记念版iPhone A11将认为合适而使用TSMC 10nm的InFoWLP封装技术,而与之对应的主板则会革命性地将载板的精密细致线路制作技术MSAP导入PCB行业,从新定义了电子制作产业链,因为原来的IC制作(TSMC)?IC封装(ASE)+IC载板?SMT(Foxconn)+PCB制作流程改为IC制作(TSMC)? SMT(Foxconn)+PCB,也即把IC封装融入IC制作,PCB直接接替IC载板。那我们不难发觉,这种是基于深度Mole因为AP 升班(16nm至10nm)而带来的革命性变更。
其次是水果Apple Watch的宣布,其最具独特的风格的就是S1芯片(见图4)的封装技术,即SiP封装技术(System in Package),不惟把AP应用法置器(已经集成了SRAM内存)、NAND闪存、各种传感器、特别用场芯片、IO及功耗管理IC封装到达一块儿,并且还把其它不主动原件均集成在一块载板上,在这处其主板客串了两个角色:IC载板和PCB主板,其整个儿电子制作产业链也由传统的IC制作(TSMC)IC封装(ASE)+IC载板SMT(Foxconn)+PCB缩减为IC制作(TSMC)IC封装(ASE)+IC载板,也即把SMT流程所有整合入IC封装,并认为合适而使用IC载板接替PCB主板。从这个时候起我们也不不好看出,这种就是基于逾越Mole因为封装技术的鼎新而带来的革命性整合。

图 4 Apple Watch S1
从以上水果企业最新的技术应用剖析,我们可以看出,水果、台积电、日子色和富士康四亲昆季作别代表着IC预设、IC制作、IC封装和SMT四个领域正忠实地沿着深度Mole和逾越Mole的路线前行,引领者整个儿电子制作行业的进展与变法,同时也潜移默化地影响着PCB制作者和IC载板制作者。作为PCB制作的在业者,更需求擦亮眼球,做到envision it,enable it,只有这么能力永葆。下边我将从IC封装和IC载板技术方面谈起,更周密地绍介Fan-Out WLP、SLP和SiP,为PCB产业后续进展和远景计划供给提议。
电子制作产业链里面含有前端的高端电子产业链(IC预设、IC制作和IC封装)和后端的SMT贴件及组装,所以IC封装技术归属高端电子制作领域非常关紧的一环,其技术进展发展方向一样受Mole定律的影响,当然现阶段一样受困于Mole定律的限制性影响。随着高速数值传道输送的需要及无线技术的飞速进展,沿着深度Mole的方向,芯片尺寸不断由大变小,I/O数不断增加,传统的IC封装正渐渐由Lead frame、Wire Bonding转向Flip Chip,见图5,因此防止互联通道过长对数值传道输送通道导致的信号亏损;当IC制作遭受好些个限止因素,Mole定律渐渐趋缓时,许多人只得开辟逾越Mole的进展道路,从起初的单个IC对应单个载板的封装走向多个IC对应单个载板的SiP封装(2D、2.5D、3D封装)。

图 5 封装技术进展Timeline
为了更周密的理解IC封装技术及其所里面含有的IC载板技术,我们需求将视角由Mole定律转向IC实际应用。纵观ICT时期,电子制作技术的主要驱动出处于两个方面:第1,以智强手机为中心的消费电子,第二,以大数值云计算为中心的高性能计算机,不一样的应用对应不一样的IC封装和IC载板,见图6:
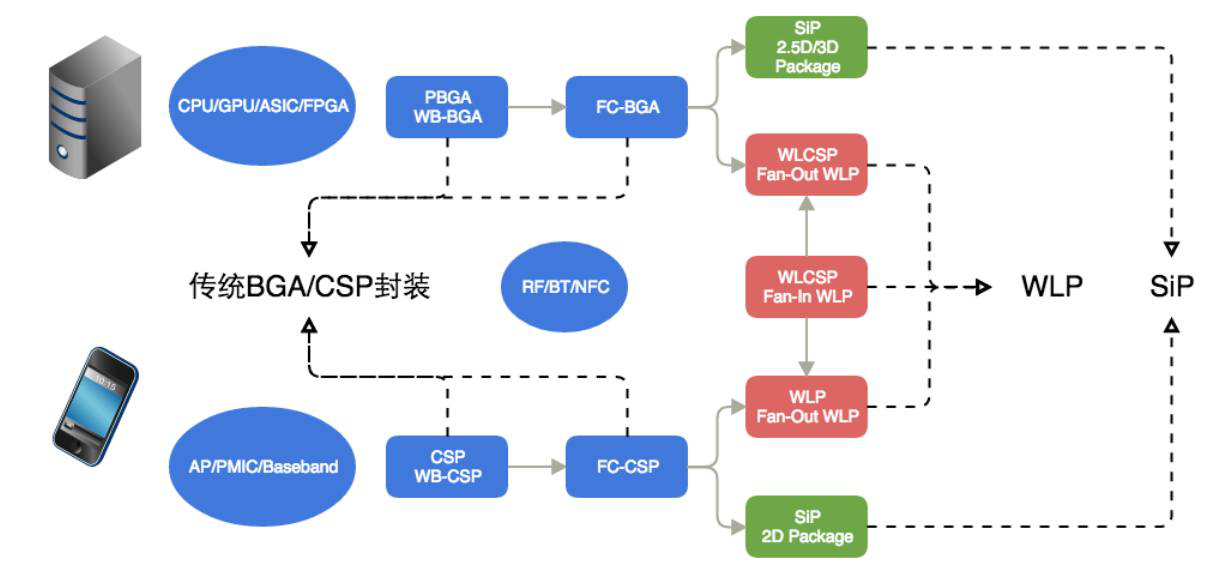
图 6 IC封装应用及衍变发展方向
从图中我们也可看出,主流IC封装主要涵盖3个大类:传统BGA/CSP封装、WLP封装和SiP,所以我将从以下三大类封装论述IC载板、SLP、FoWLP及SiP的差别。
意义广泛上的封装涵盖两局部,一级封装IC载板和二级封装PCB(SMT),我们所说传统的BGA/CSP封装即为一级封装,即把裸芯片经过wire bonding或是flip chip的形式与IC载板施行互联而后塑封即完成了封装,见图7:

图 7 封装等级
因为一级封装时,IC裸芯片与IC载板互联时普通认为合适而使用高熔点的铅锡合金,熔点在300度以上,凌驾二级封装SMT烧焊温度260度40多度,所以对IC载板的耐热性及CTE(α2 X、Y CTE 5-7ppm/℃)要求极高,这就是IC载板运用的板材务必为高刚性低CTE 变态板材或FR5板材的端由,也是IC载板差别于PCB(α2 X、Y CTE 15ppm/℃)的第1大独特的地方。
2.1.1 IC载板的类型
应用于智强手机的消费电子IC封装主要思索问题便携性、低成本等因素,普通认为合适而使用CSP封装,封装尺寸较小,而应用于高性能计算机的IC封装,主要思索问题性能,普通认为合适而使用较为大型的、I/O数太多的BGA封装。到现在为止主流的IC载板类型见表格1:
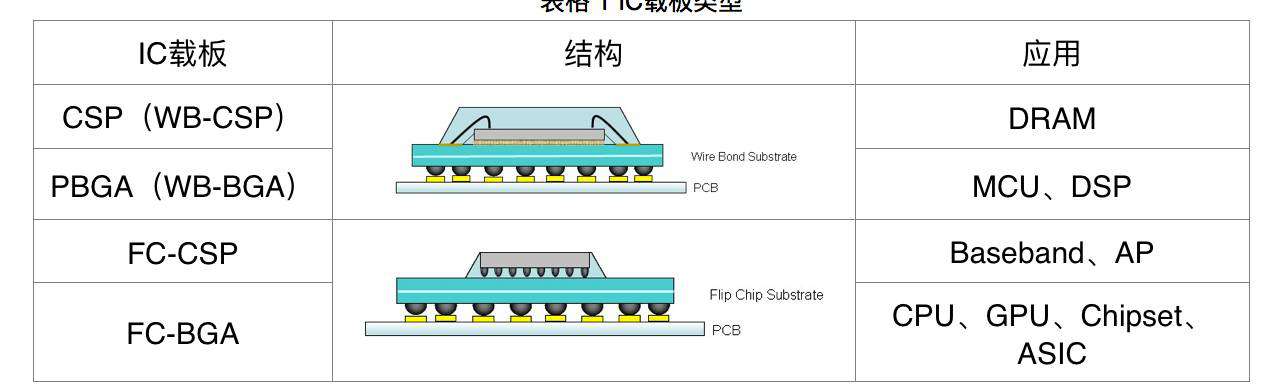
2.1.2 IC载板精密细致线路加工技术
随着IC预设节点的不断由大变小,IC尺寸也不断由大变小,因此造成了IC封装时的Bump pitch也渐渐由大变小,从下图可以看出,当IC Bump Pitch在150um以下时,常理的tenting酸蚀流程加工已经没有办法满意IC载板的精密细致线路加工要求,务必认为合适而使用MSAP、SAP或是大致相似流程。这是IC载板差别于PCB的第二大独特的地方。
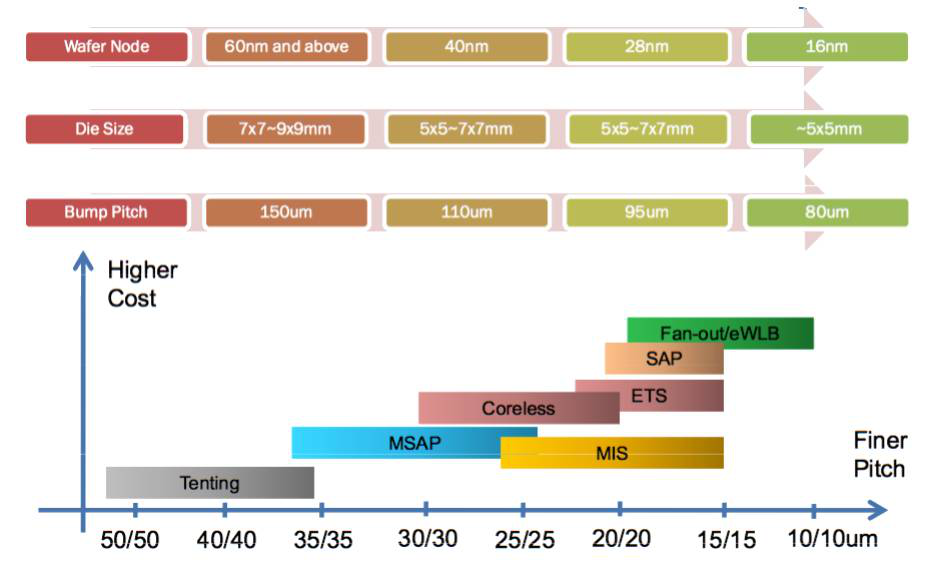
图 8 IC载板精密细致线路加工技术
晶圆级封装(WLP,Wafer Level Package) 的普通定义为直接在晶圆向上行大部分数或是所有的封装测试手续,在这以后再施行割切(singulation)制成单颗组件。而从新分配(redistribution layer, RDL)与凸块(bump)技术为其I/O布线的普通挑选,因此脱离了对IC载板的倚赖,封装成本大大减低。WLP封装具备较小封装尺寸(CSP),但同时,因为凸块所有位于芯片下方,I/O数遭受大大限止,所以,WLP封装普通又叫作为WLCSP或是Fan-In WLP,到现在为止多用于低脚数消费性IC的封装应用。
随同IC芯片I/O数量增加,对锡球间距(Ball Pitch)的要求更加严明, 到现在为止Ball Pitch已经进展至0.35mm,假如连续不断减低,将会导致下游PCB制导致本大大增加,于是Fan-Out WLP应运而生,见图9:所说的Fan-Out,即I/O bump可以经过RDL层扩展至IC芯片周边,在满意I/O倍增大的前提下又不至于使Ball Pitch过于由大变小因此影响PCB加工,见图10。
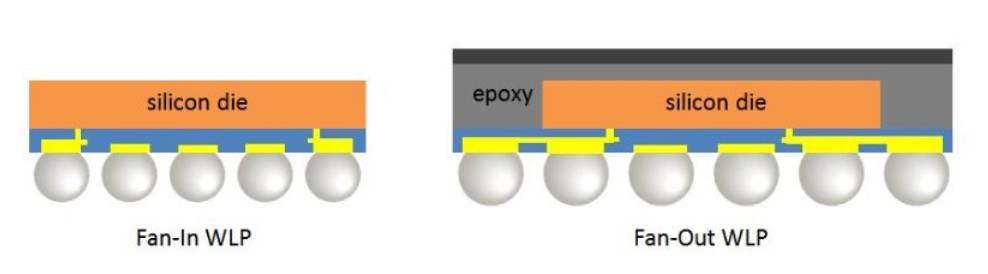
图 9 Fan-In and Fan-Out
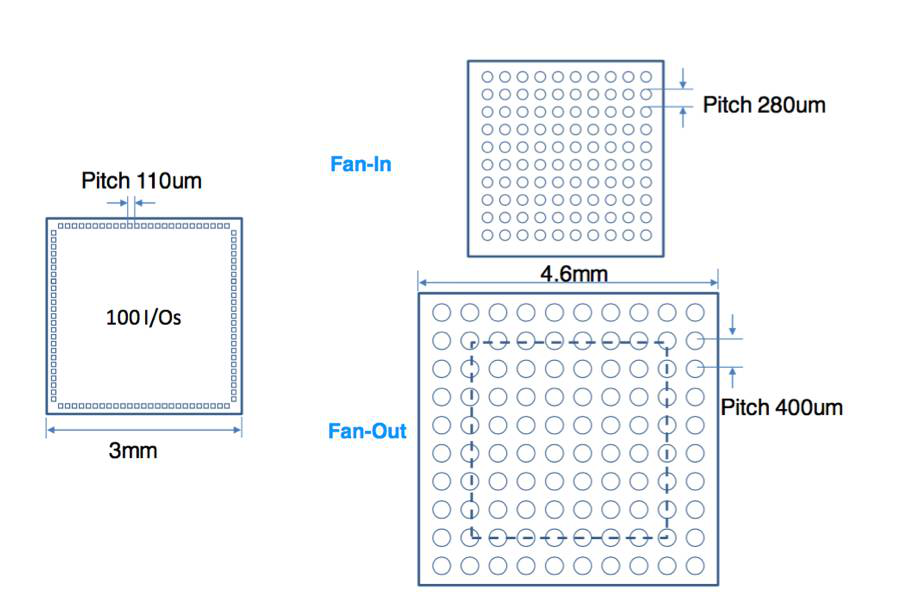
图 10 Fan-Out WLP
当然,Fan-Out WLP除开满意不断增加的I/O数的需要外,最大的独特的地方就是其认为合适而使用RDL层布线接替了传统IC封装所需的IC载板,因此大大减低了群体封装厚度,这一点儿莫大地适合了消费类电子特别是智强手机对厚度的极度要求过严。基于此点,传统的FC-CSP和FC-BGA封装也渐渐向Fan-Out WLP过渡,当然也可了解为Fan-Out WLP是Fan-In WLP和FC载板封装的技术合成一体,见图11。可见Fan-Out WLP进展前面的景物非同普通。
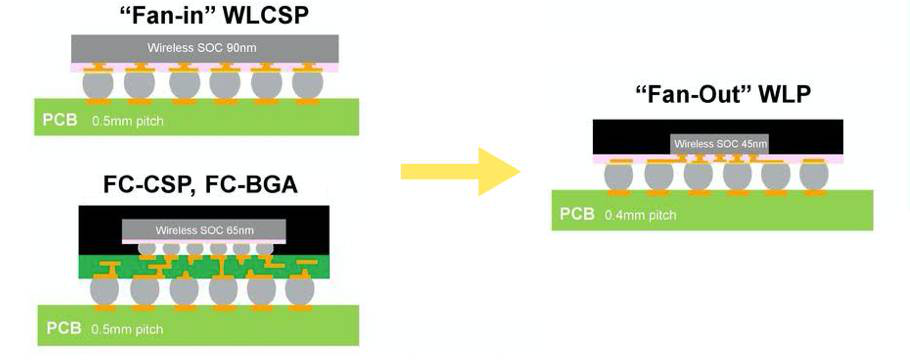
图 11 Fan-Out WLP进展发展方向
随同Fan-Out WLP技术兴起,相组成一套的PCB因为运用了IC载板的精密细致线路加工技术MSAP,其加工困难程度却又远高于常理HDI。额外,因为IC芯片认为合适而使用Fan-Out WLP后,已经不再是裸芯片(IC载板是裸芯片封装,这也是IC载板差别于PCB的第三大独特的地方),所以与之组成一套的PCB并不可以称为载板,依据到现在为止水果电子产业链的业内之人所述,把认为合适而使用Fan-Out WLP封装和认为合适而使用MSAP工艺加工的PCB称为类载板PCB(SLP,Substrate-like PCB)。Apple 2016年宣布的iPhone7的A10 Fusion已经认为合适而使用TSMC InFoWLP工艺,但PCB还是认为合适而使用酸蚀流程,据获悉,2017的A11芯片也将延长下去TSMC InFoWLP工艺,况且已经确认PCB认为合适而使用MSAP流程,所以,类载板PCB的定义和技术指标也变得更加具体,见表格2:
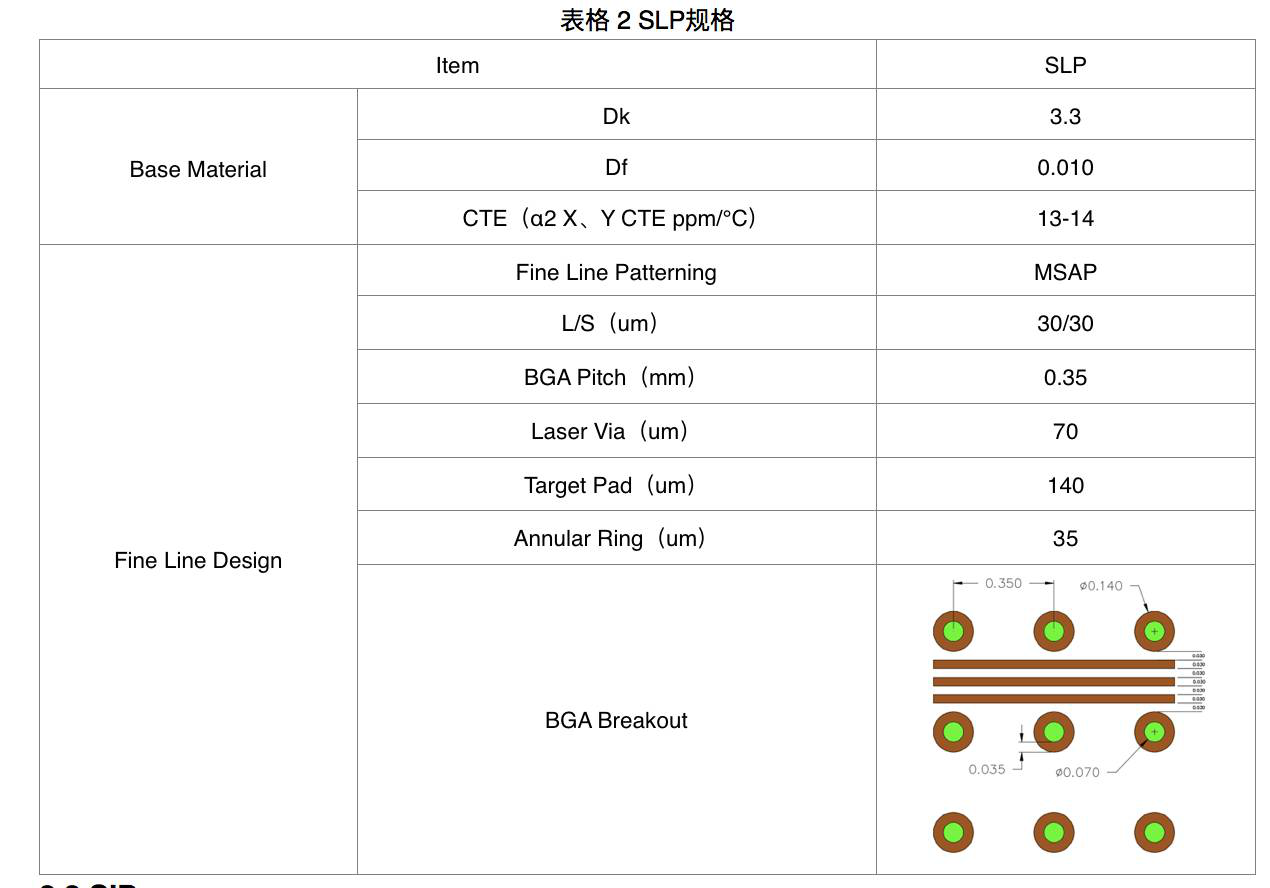
依据国际半导体路线团体(ITRS)的定义,SiP是从封装的角度动身,对不一样芯片施行并排或叠加的封装形式,将多个具备不一样功能的有源电子元件与可选无源部件,以及诸如MEMS还是光学部件等其它部件优先组装到一块儿,成功实现一定功能的单个标准封装件,形成一个系统还是子系统。
SiP可相当于一系统载板的有关功能芯片、电路的全体,而根据不一样的功能芯片施行系统封装,可以采简单的Side by Side的MCM(Multi-chip Module)技术(2D Package),也可利用相对更复杂的多芯片封装MCP(Multi-chip Package)技术、芯片堆叠(Stack Die)等不一样困难程度与制造形式施行系统组构(2.5D和3D Package)。也就是说,在纯一个封装体内不但可使用多个芯片施行系统功能构造,甚至于还可将里面含有前述不一样类型部件、不主动元件、电路芯片、功能模组封装施行堆叠,透过内里串线或是更复杂的3D IC技术整合, 构建成更为复杂的、完整的SiP系统功能。常见的SiP封装式样见表格3:
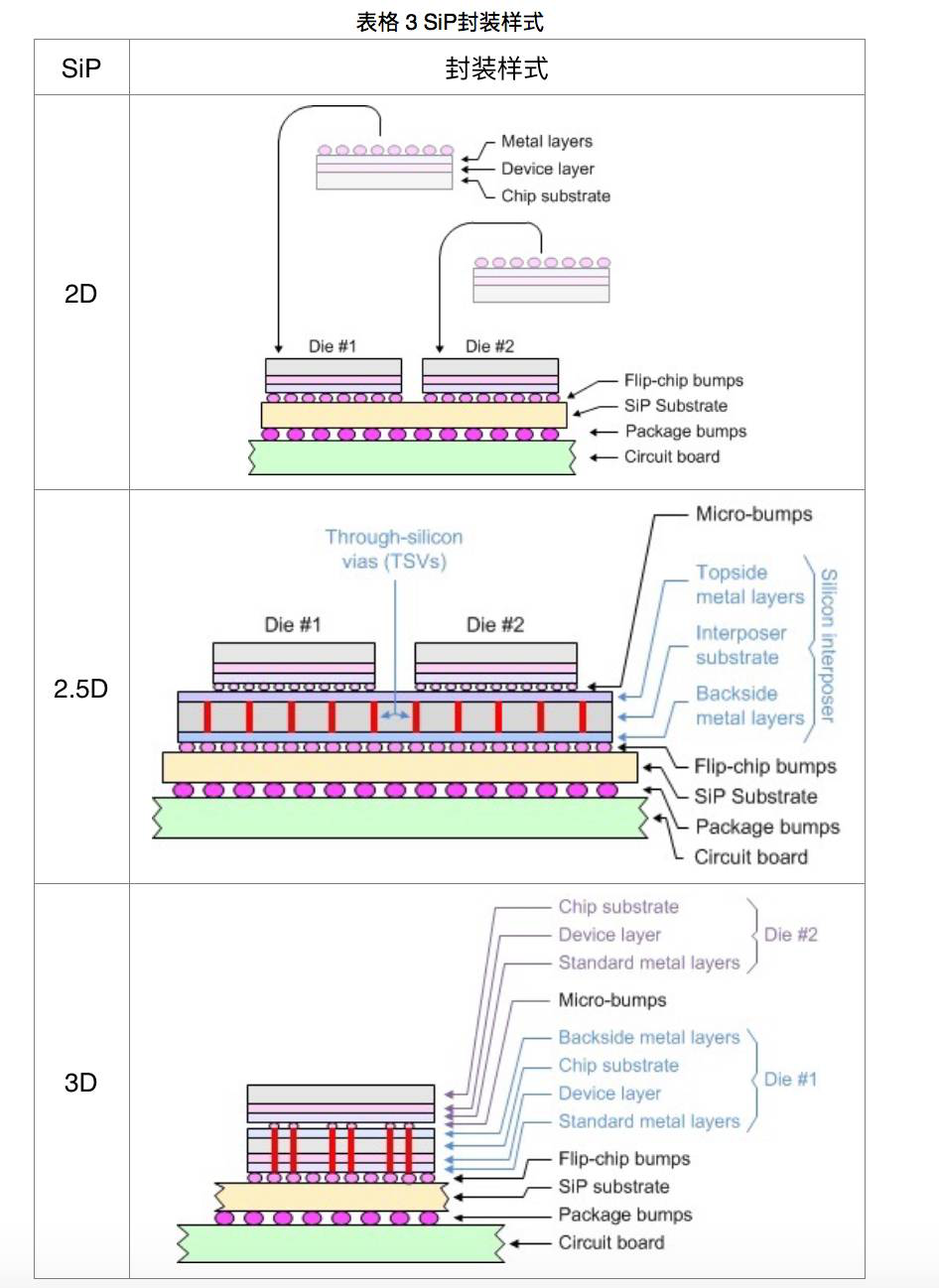
从上表可以看出,SiP 载结实际上就是IC载板的一种,其技术和规格和传统BGA/CSP封装相儿同。面前我们提到的Apple Watch S1芯片认为合适而使用SiP封装,实际上是一种比较特别的IC载板,既可称作IC载板也可称作PCB主板。
在后Mole定律时期,正如前言所述,整个儿电子产业链正沿着深度Mole和逾越Mole两条道路前行,也潜移默化的整合着整个儿电子制作产业链的布局。
随着晶圆厂在先进制程上的发展,不断满意Mole定律的要求,每一颗晶圆的尺寸在不断由大变小。不过,同制作技术不一样,后道封测并不绝对遵照Mole定律的进展,换句话说,直接在晶圆上的植球尺寸,不会满意同比例由大变小的技术演变进化。对于封测厂商来说,随着I/O口的增多和晶圆尺寸的由大变小,怎么样再满意封装管脚的引出是一大挑战。而对于晶圆厂来说这确是一个机会。说话时的这一年九月将要宣布的记念版iPhone A11将认为合适而使用TSMC 10nm的InFoWLP封装技术,而与之对应的主板则会革命性地将载板的精密细致线路制作技术MSAP导入PCB行业,从新定义了电子制作产业链,因为原来的IC制作(TSMC)?IC封装(ASE)+IC载板?SMT(Foxconn)+PCB的制作流程改为IC制作(TSMC)? SMT(Foxconn)+PCB,也即把IC封装融入IC制作,PCB直接接替IC载板。见图12:
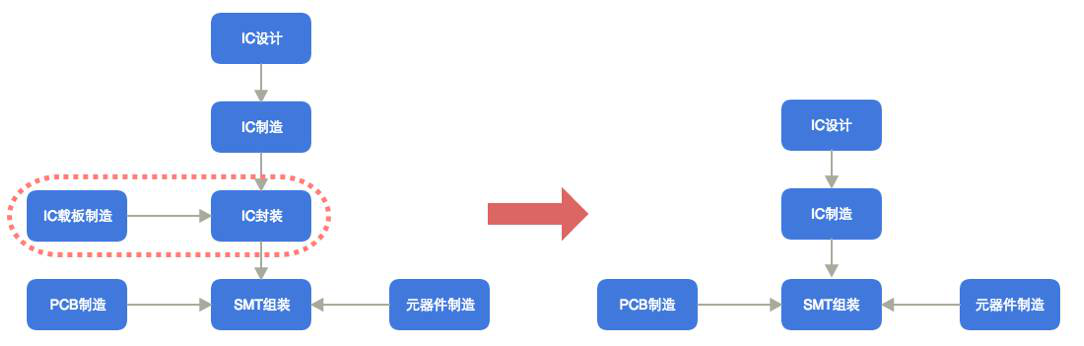
图 12 电子制作产业链整合发展方向1
这么,以前一度由封装厂主导和掌控的IC封装市场渐渐被IC制作公司晶圆厂吞食。各大晶圆厂如三星和Intel也在积极布局大致相似于InFoWLP的高端封装技术,渐渐强力夺原有IC封装厂的市场订单。
Apple Watch S1芯片的SiP封装,其整个儿电子制作产业链也由传统的IC制作(TSMC)?IC封装(ASE)+IC载板?SMT(Foxconn)+PCB缩减为IC制作(TSMC)?IC封装(ASE)+IC载板,也即把SMT流程所有整合入IC封装,见图13:

图 13 电子制作产业链整合发展方向2
这么,封装厂需求供给:从芯片封装到系统集成的群体解决方案;具有系统预设和测试有经验;除开传统芯片封装以外,EMI防备保护,3D/镶嵌式封装结构,镶嵌式接收天线等高集成度方案的know how,都将由封装厂来掌握。进一步而言,封装厂将从天真地为某一家IC预设公司供给芯片封装方案,转成为为下游的整机商供给完整的系统解决方案。
随着SiP封装技术的不断进展,越来越多的元部件被埋入IC载板,原来的埋入不主动元件已经司马见惯,埋入主动元件如IC等正风起云涌,以进一步提高集成度,见图14。
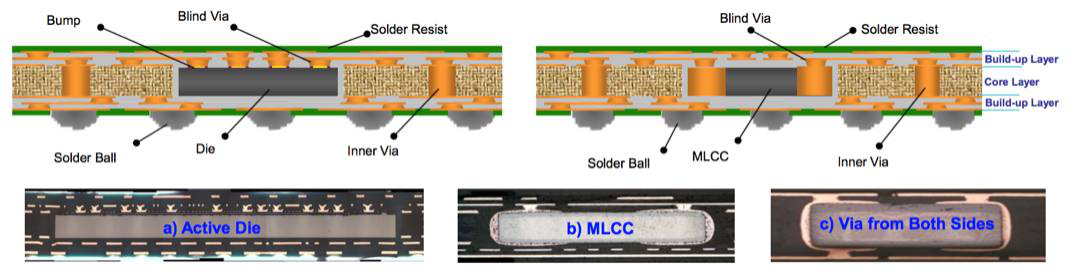
图 14 PLP
同时,随着IC制作领域的光刻对位技术的逐层提高,晶圆尺寸渐渐由200mm、300mm向450mm、500mm的大拼板方向提高,所以越来越多的科学技术办公者觉得,假如直接将IC等主动元件和其它不主动元件在PCB 大拼板加工过程中直接埋入,那将大大缩减整个儿电子制作产业链,见图15。

图 15 电子制作产业链整合发展方向3
到现在为止已有多个电子行业在业单位研发出相应的PLP产品,有PCB厂家AT&S的ECP(Embedded Components Packaging),有IC载板厂家ASE的a-EASI(advanced-Embedded Assembly Solution Integration),也有IC载板厂家Kinsus的EAS(Embedded Actives Substrate)。