1997年,富士通推出了“凸点芯片载体(BCC)”封装并获得了许可证,无铅引线框架封装首次得到广泛采用,工业基础设施也得到了发展[1]。UTAC Thailand(以前是NSEB)是BCC技术的早期被许可方。在过去的17年里,在密度、厚度、可靠性和性能方面不断进步,这使得无铅引线框架包装预计将成为最大的包装细分市场,2014年的出货量接近每周10亿件[2]。这些基于无铅引线框架的封装可能有不同的供应商名称,但四扁平无铅(QFN)的JEDEC名称是主要的封装类型,将在本文中通用。绝大多数QFN封装都有一排外围焊盘,限制了它们在低引脚数设备上的应用——通常低于100个。
本文提供了最近完成的2013年MEMS产业商业化报告卡研究(报告卡)[1]的结果。该成绩单从1998年起每年出版一次。为了确定报告卡的具体主题,对技术商业化的一般主题进行了市场研究,并选择了一些关键的成功因素(又名主题),这些因素被认为是MEMS和MEMS行业成功商业化所必需的。
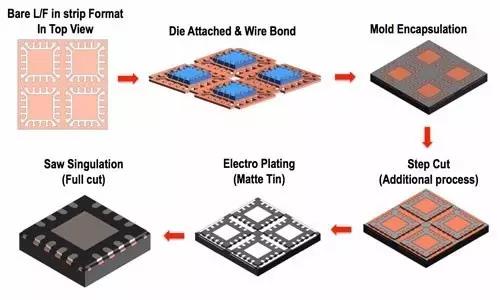
WFN侧镀铅流程图1。
QFN封装的广泛采用和快速增长是由于其成本和尺寸优势,传统的引线封装如小轮廓集成电路(SOIC)和QFP。然而,恶劣的环境和高可靠性的应用,如汽车,要求在无铅结构方面取得进展,以实现完整的焊点圆角,从而实现自动光学检查(AOI)系统,以验证所有引线都具有焊点圆角,从而确保最佳的焊点完整性,以承受温度循环寿命、焊接疲劳和机械振动或冲击故障。为了使焊点圆角饱满,必须改进锯和冲孔分离工艺,以确保周边铜线的侧壁电镀,以使焊料润湿。图1概述了在电镀铅之前添加一个台阶切割工艺的工艺流程,以实现周边铅侧面的电镀。
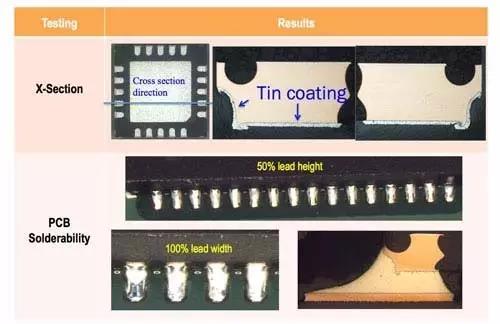
图2:QFN侧镀铅横截面图。
图2提供了横截面图,以验证台阶切割深度的控制和铅基和侧壁侧面的哑光镀锡层的均匀厚度。在表面贴装可焊性测试后包括横截面图,以证明50%的引线高度和100%的铅宽焊料覆盖率。UTAC QFN包装多年来采用了优化的材料组和工艺,以确保JEDEC湿敏性水平1(MSL1)在265°C下。添加阶梯切割和侧边铅镀层也符合MSL1的要求。UTAC内部董事会级别的完整可靠性结果将于2014年第四季度完成。汽车应用的最终用户已经完成了他们的内部认证,UTAC正在生产汽车应用的侧面镀铅QFN封装。预计航空航天和恶劣环境的工业应用也将看到侧镀QFN引线在其高可靠性应用中的优势。
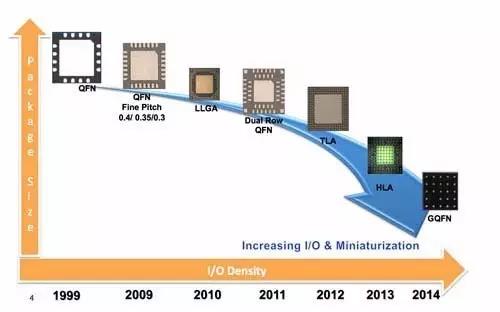
图3:UTAC无铅引线框架里程碑。
为了解决更高I/O密度的应用,IC设计人员一直在要求一种低成本的QFN封装解决方案,该解决方案包括互连跟踪布线,以实现多行和全阵列焊盘配置。许多解决方案已经开发出来,以实现多排铅密度,其中一些已在生产中取得了一些成功。图3提供了UTAC自1999年在BCC取得早期成功并添加QFN以来推出的新型无铅引线框架解决方案的里程碑。这些新的高密度无铅引线框架封装的详细信息,如无铅引线框架网格阵列(LLGA)、热无铅阵列(TLA)和高密度无铅阵列(HLA),已在行业出版物[3–6]中报告。然而,供应链、成本和可制造性障碍限制了这些解决方案的采用和推广。因此,人们寻求利用标准装配工艺的新方法,以使用引线框架跟踪路由技术服务于要求最高I/O密度的应用。联合技术公司最近的进展显示了克服这些障碍的希望,并正在扩大规模,以实现大批量生产。工艺和材料技术的进步使得具有高密度引线布线和互连的多排和全网格阵列焊盘密度能够服务于集成电路设计人员的各种单芯片、多芯片和无源集成配置;本文将使用缩写GQFN作为网格阵列QFN。
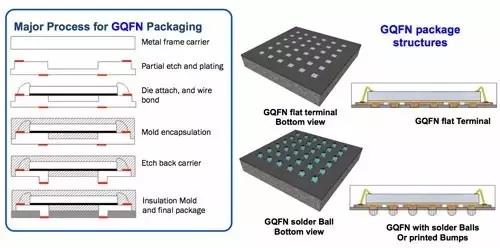
图4:UTAC GQFN(网格阵列QFN)过程。
图4说明了使用基于可路由引线框架的技术实现的关键流程和区域阵列配置。一个部分蚀刻和预镀引线框架的设计,制造和交付到封装装配线,在那里进行芯片连接和导线键合。(倒装芯片、叠层模具和被动集成选项均受支持,但此处未显示。)在模具/模具后固化之后,使用了两个关键过程,如果使用标准QFN工艺流程,则找不到流程。这两个过程是:1)蚀刻引线框架载体背面以完成迹线布线并隔离预镀引线,然后2)绝缘模具过程以完成封装。如果产品板表面贴装组件的要求,印刷焊料凸点或更高的间距球下降可以完成之前,封装锯单。
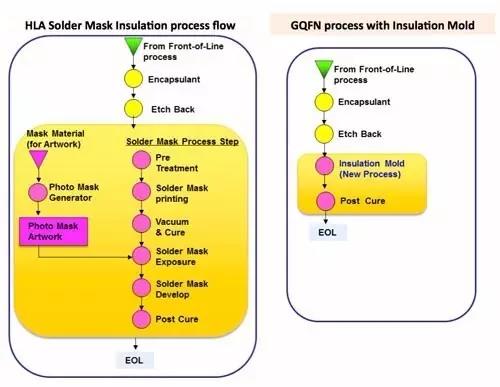
图5:绝缘模具与焊接掩模绝缘。
从BCC技术开始,蚀刻背在无铅引线框架生产中已经使用了很多年。基于焊接掩模的铅绝缘工艺已被引入作为区域阵列QFN的高密度无铅阵列(HLA)解决方案,但如图5所示,与GQFN封装的绝缘模具工艺开发相比,它需要复杂的多步骤工艺流程。与这种焊接掩模绝缘工艺相关的挑战增加了成本和制造挑战,限制了HLA解决方案的采用和扩大。为了解决这些局限性,联合技术评估了各种方案,并专注于为GQFN开发绝缘模具工艺。绝缘模具工艺也带来了装配挑战,并进行了全面优化以应对这些挑战。在开发过程中,必须克服许多工艺和材料因素,才能提供高容量的绝缘模具工艺。因素包括:1)模具工具设计-型腔、浇口、流道和通风口;2)薄膜辅助成型–薄膜材料和工艺参数;3)模具夹持压力、转移轮廓和压力;4)模具材料特性和精细填充技术。

图6:GQFN电线焊接工艺选项。
图6说明了可用于引线键合设备的关键工艺选项。引线框架选项包括4或5 mil的铜载体,采用NiPdAu或选择性镀锡。模具厚度为4密耳的环氧糊料或模具附着膜(DAF),正在开发中,以使2至3密耳模具厚度与使用DAF。金属丝的选择包括各种金属丝直径的Au,PdCu或Ag合金。模具盖的范围从0.75mm(叠层模具或厚组件系统封装(SiP)配置)到0.25mm(对于薄封装应用,需要0.5mm的最大封装厚度)。计划开发需要带状连接或铜线夹组装的电力设备。
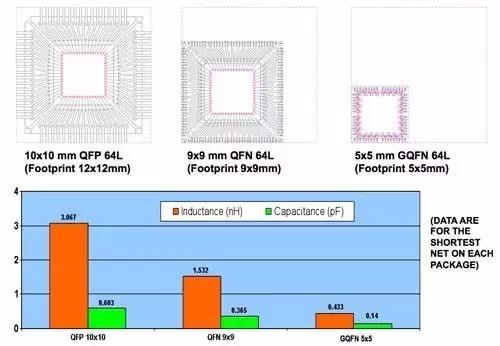
图7:电气性能比较:QFP/QFN/GQFN。
目前GQFN技术的设计使封装尺寸比QFN减少了40%到60%,因为它们能够在模具区域下布线引线。这种技术的更高的互连密度使键合指的定位更加灵活,从而改进布线图,以处理复杂的焊盘布局和多层、叠层模具和SiP配置。如图7所示,较短的导线长度可以提供具有较低电感和电容的改进的电气性能。这里显示了GQFN与64引线QFN或QFP封装的封装尺寸和电气性能优势。对于射频和电源管理SiP应用,除了降低电寄生性能外,在SiP应用中广泛使用的基于有机衬底的陆地网格阵列(LGA)封装中,GQFN显示出较低的热阻,提供了更好的电性能和热性能。

图8:a)(左)GQFN 5xx0.45mm,79根引线的封装结构;b)(右)a GQFN封装横截面。
移动应用需要新的封装技术来在更严格的温度循环应力和跌落冲击用例下保持焊点的完整性。为了评估栅极阵列QFN技术的BLR,测试了一个5xxx0.45mm 79引线GQFN和一个2.9x2.6x0.1mm模具。由于这种79导联GQFN设计比QFN减少了60%的封装尺寸,增加的芯片封装比对电路板级可靠性提出了担忧,因为封装和PCB之间的硅热膨胀系数(CTE)不匹配将对焊点产生更大的影响,尤其是在芯片边缘区域下的焊点。GQFN 5x5x0.45mm 79引线的封装结构如图8所示。

图9:TCoB:Weibull图。
5x5mm超薄(XGQFN)封装是表面贴装的,安装在200x150mm板上,并进行加速寿命试验,以确定其二级可靠性。温度循环加速试验条件为-40°C至125°C,停留/斜坡15分钟。威布尔图(图9)显示了特征寿命,其定义为63.2%试验部件失效的寿命周期数。虽然模具封装比非常高,为58%,XGQFN 5x5mm具有优异的TCoB性能,首次失效为2680次循环,特征寿命为4600次循环(图9)。

图10:跌落试验:威布尔图。
高要求的手机使用案例正在推动机械跌落冲击阻力目标的提高,客户需要的数据最多可达1000次跌落周期。XGQFN 5x5mm封装安装在132x77x1.0mm的8层板上,设计用于形成集成菊花链。试验方法包括使用跌落台从规定高度自由跌落电路板,该高度与JEDEC条件B(1500 Gs,0.5ms持续时间,半正弦脉冲)相对应,如JESD22-B110表1所示。XGQFN 5x5mm封装具有优异的跌落性能,第一次故障为470次循环,特征寿命为950次,通过了移动用户苛刻的测试标准(图10)。

图11:GQFN中带有铜柱凸起的FC。
在QFN封装中使用倒装芯片与铜柱碰撞相结合的密度优势将使更广泛的设备和应用能够利用倒装芯片封装固有的尺寸、热性能和电性能优势。图11显示了一个设计的横截面,该设计利用GQFN封装中的倒装芯片铜柱来提供一种独特的散热垫和信号焊盘的布置。该设计实现了一个小型封装,具有较高的模具封装尺寸比,以及良好的热性能和电气性能。
无铅引线框架组件、材料和工艺技术的进步使QFN封装能够通过提高可靠性和更高的I/O密度来解决具有挑战性的应用和设备要求。在电镀铅之前添加一个步骤切割工艺,可以电镀铅侧壁侧面,从而通过形成完整的焊料角来改善焊点的完整性和AOI检查。这种改进使得QFN封装可以用于恶劣或更高温度的应用,以更好地满足汽车市场驱动的高可靠性要求。绝缘模具工艺的发展解决了许多制造难题,这些挑战一直限制着多排和面阵QFN封装的采用和应用。坚固的蚀刻背衬和绝缘模具工艺相结合,使QFN封装具有更高的I/O密度和设计灵活性,使网格阵列QFN(GQFN)封装能够解决迄今为止需要2到4层有机层压细间距球栅阵列(FBGA)或LGA封装的设计。GQFN技术允许倒装芯片、叠层模具和被动式集成到基于引线框架的低成本封装中,以推动无铅引线框架应用的持续增长