IC封装板是指根据产品型号和功能要求对被测晶圆进行加工,获得独立芯片的过程。 IC封装主要是提供一种介质,将精细的硅芯片连接到间距较粗的印刷电路板上,并保护器件不受潮。
具体的包装形式包括:
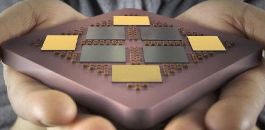
1.铅包
1970 年代末,市场上第一个被广泛接受的封装是双列直插 (DIP),采用陶瓷和塑料封装。引线从封装的两侧引出并垂直于封装。通过将引脚插入电路板的通孔中,可以将封装安装在PCB板上,然后将引线夹在电路板的另一侧,然后通过波峰焊技术进行焊接。此封装可容纳的最大引线数为 40,板间距为 0.65mm。
在 1970 年代末和 80 年代初,出现了表面贴装。芯片上的引线(引脚)和元件焊接在电路板的某个表面上,而不是穿过电路板。这使得电路板的两面都可以用于键合芯片,在安装过程中使用回流焊技术,最大引脚数为80。
到 1980 年代中期,出现了四面都有引线的封装。这种封装称为四方扁平封装 (QFP)(引线呈海鸥翅膀形状)或引线芯片载体(引线弯曲)。 J 形)。最常用的典型四方扁平封装间距为0.65mm或0.5mm,引线数量高达208根。这些封装在1990年代初期广泛应用于硬盘驱动器和图形市场。
在 1980 年代末和 1990 年代初,Exposed-Pad Leaded Package 诞生了。这种封装是四方扁平或更小的外形封装,芯片键合端暴露在底部。这些暴露的键合端可以焊接在电路板上,为芯片建立有效的散热路径。
微型引线框架 (MLF) 系列封装是在 1990 年代开发的。 MLF 靠近 Chip Scale Package (CSP),封装的底部引线端用于提供与 PCB 板的电接触,而不是海鸥翼形引线 Soic 和 qual 封装,因此,这种封装有助于确保散热和电气性能。
2.分层包装
1990年代,出现了一种新型封装,采用分层板作为基板材料,称为球栅阵列(BGA)。基于引线框架的封装只能将引线引到封装的外围……球栅阵列封装的引线可以被引导到整个封装底部的焊球。最初,BGA封装板的典型焊球间距为 1.27 毫米。
3. 晶圆级封装
当有空间要求时,最好的包装是完全没有包装。可以在晶圆级进行额外的处理,以生产可以直接安装在电路板上的设备。这种处理一般包括使用重分布层将晶圆上的细间距转移到芯片本身的较粗间距(典型值0.5mm),然后在重新排列的功能上产生凸点。管芯会被单独分割,晶圆级封装是凸块管芯。
4. 系统级封装 (SIP)
现在新一轮的集成是将多个芯片放在一个封装中,成为系统级封装(SIP)。多芯片封装可以通过在同一个封装中放置两个或多个芯片(通常使用分层基板),或者在同一个封装中将一个芯片堆叠在另一个上面来实现。
5、封装互连技术的发展
互连技术描述了芯片如何连接到封装基板。在大多数封装中,首先将封装体接合到基板(引线框架或分层)上的芯片连接端子的前表面,然后使用金线或铝线将芯片焊盘接合到基板的引线指。优越的。这种互连技术称为引线键合,适用于大多数封装应用。一种新的互连方案称为倒装芯片键合(Flip Chip Bonding)。在焊盘位置的芯片表面上产生导电凸块。然后将凸块芯片倒装并直接连接到基板。在大多数情况下,使用分层基板。焊球粘附将使用回流焊工艺。连接基板并回流后,芯片和基板之间采用底部填充工艺,以减少器件在使用时焊接部分引起的应力.
6. 包装材料 塑料包装容易受潮和潮湿。最初的封装是通孔安装,可靠性要求不是太高,因为焊接过程中产生的热量离封装很远(在电路板的另一侧)。该行业一直在努力改进模具组合和芯片连接材料,以消除干式组装的需要。对包装材料的另一个最新要求是包装中完全无铅,并使用符合环保要求的“绿色材料”。
7、包装工艺 上道晶圆工艺的晶圆经过划片工序后,被切割成小晶圆(Die),然后将切割的晶圆粘在基板(引线框架)框架的相应岛上,然后使用超细用金属(金、锡、铜、铝)线或导电树脂将芯片的焊盘与ic封装基板的相应引线连接,形成所需的电路;然后独立的芯片被封装并用塑料外壳保护。塑料封装后,需要进行模后固化、修边成型、电镀、印刷等一系列操作。包装完成后,对成品进行检测,通常要经过来料、检测、包装,最后入库和发货。 典型的包装工艺:切割、装载、粘合、塑料包装、去毛边、电镀、印刷、切割肋条和成型、外观检查、成品检测、包装和发货。