在 SMT 产线上有一个公认的数据:60% 到 70% 的焊接缺陷,追根溯源都能回到焊膏印刷这个环节。这不是理论推算,而是来自大量产线统计和失效分析的结果。换句话说,印刷这道关口守住了,后续的贴片和回流焊就少了一大半麻烦。但印刷本身又是一个变量极多的过程 —— 钢网、焊膏、刮刀、环境温湿度、设备精度,每个因素都在互相拉扯。下面我从实际产线经验出发,把这几个环节串起来讲。
印刷前先要看:焊膏选型的几个关键决策点
焊膏不是越贵越好,关键是匹配。选型时我一般盯住三个维度。
第一个是颗粒度。颗粒度必须和钢网开孔尺寸匹配,行业内有个 “五球法则”:钢网开孔最小尺寸至少是锡粉最大粒径的 5 倍。比如 Type 4 锡粉(20-38μm),最大粒径 38μm,乘以 5 等于 190μm,意味着钢网开孔最小尺寸不能低于 190μm;如果是 Type 5(15-25μm),最小开孔尺寸可以做到 125μm。选错了颗粒度,印刷时钢网堵孔会频繁发生,产线调试根本调不过来。
第二个是粘度。粘度太大,焊膏不容易穿过钢网开孔,印出来的线条残缺不全;粘度太低,印完后焊膏容易流淌和塌边,细间距器件会桥连。实际采购中,不同品牌或批次的锡膏粘度差异可能超过 20%,所以换批次后即使参数不变,印刷效果也可能完全不同。一个简单的现场判断方法是:用刮刀搅拌焊膏约 30 分钟后挑起少许,让它自然落下 —— 如果慢慢逐段落下,粘度适中;如果根本不滑落,粘度太大;如果快速滑下,粘度太低。
第三个是免洗还是水洗。消费类电子产品通常走免洗路线,节省一道工序;但医疗电子、军工、高阻抗电路等,残留的助焊剂在潮湿环境下会产生离子迁移,形成枝晶短路,这类产品必须清洗。选免洗焊膏时,要确认其残留物在最终使用环境下不会产生导电通道。
六个核心参数的耦合逻辑:它们不是独立设置的
焊膏印刷参数之间是相互制约的关系 —— 改了刮刀速度,刮刀压力得跟着调;调了脱模速度,钢网与 PCB 的间距也要重新确认。如果没有这个耦合意识,单个参数怎么调都调不到位。
刮刀压力是控制焊膏填充钢网开口的核心变量。压力过小,焊膏填不满开口,导致少锡;压力过大,焊膏被强制挤到钢网底部,印出来过量,回流后桥连。通常设定在 50-150N 之间,具体要看钢网厚度和焊膏粘度。实际调试时,我会用压力传感器确认实际值,而不是只看机器的表盘读数,因为机械损耗会导致显示值与实际值有偏差。
印刷速度影响焊膏在钢网表面的滚动状态。速度太快,焊膏来不及充分填充开口,印出来不饱满;速度太慢,焊膏停留时间过长,助焊剂提前挥发,容易拉尖。一般设置在 20-80mm/s。细间距器件(如 0.4mm pitch)建议降到 30mm/s 以下,给焊膏足够的填充时间。压力与速度的耦合关系需要特别注意:速度调快后,如果压力不跟上去,开口填充效率会同步下降。
刮刀角度决定了刮刀对焊膏垂直方向施力的大小。最佳角度在 45°-60° 之间,此时焊膏有良好的滚动性。如果角度超过 80°,垂直方向的分力几乎为零,焊膏只能在钢网表面滑动而无法被压入开口。刮刀角度通常在设备安装阶段设定后较少变动,但刮刀刀片磨损会使实际角度漂移,定期检查刀片状态很关键。
脱模速度与距离是细间距印刷最容易出问题的环节。脱模速度过快,焊膏与钢网侧壁的粘附力来不及释放,会拉回一部分焊膏,造成拉尖或锡量不足;速度过慢,焊膏可能粘在钢网上不下来。成熟的工艺通常采用两段式脱模:初始慢速(0.5-1mm/s)消除粘附力,后段快速提升效率,脱模距离一般设在 2-5mm。细间距印刷时,脱模速度是影响成型质量最关键的一个变量,值得花时间做正交实验找到最优窗口。
钢网与 PCB 的间距决定了印刷厚度的均匀性。理想状态下钢网紧贴 PCB 表面,但因 PCB 翘曲,通常保留 0-0.1mm 间隙,用真空吸附或支撑针补偿。间距过大,焊膏受压后向四周扩散,细间距位置极易桥连。
清洗频率与方式直接影响钢网开孔的一致性。焊膏在钢网开口侧壁累积,不及时清洗会缩小有效开孔面积,引发少锡。通常每印 5-10 块板做一次全清洗,细间距产品这个频率还要提高。清洗方式分干擦、湿擦和真空吸附,湿擦加真空的组合效果最好,但要注意溶剂用量不能过多。

产线上最常撞见的几类印刷缺陷与排查路径
出现印刷缺陷时,最忌讳的是上来就调参数。我的习惯是先判断缺陷的分布模式 —— 是整板性的还是局部性的、是随机出现的还是固定位置的 —— 再按优先级逐项排查。
少锡 / 漏印是最常见的缺陷,钢网堵孔是第一嫌疑人。如果发现少锡集中在某些固定位置,先检查对应钢网开孔是否被残留焊膏堵塞。如果是整板性少锡,优先查刮刀压力是否偏低、印刷速度是否过快导致填充不充分、以及焊膏粘度是否偏高。
连锡 / 桥接在细间距器件上尤其容易发生。排查顺序是:先看脱模速度是否偏慢或脱模距离不足导致相邻焊盘间的焊膏拉丝;再看刮刀压力是否过大将焊膏挤出开口边缘;最后查钢网与 PCB 间距是否偏大导致焊膏受压扩散。
拉尖是指印刷后焊膏边缘呈锯齿状或向上凸起,根本原因是脱模时受力不均。常见原因包括:刮刀压力不够导致钢网表面刮不干净、脱模速度过快、焊膏粘度偏大。优化方法:先确认刮刀能把钢网表面刮净,再调脱模速度,最后才考虑是否需要更换焊膏。
焊膏偏位表现为印刷图形与焊盘位置偏移。先检查 PCB 定位是否松动,MARK 点识别是否有误差;如果是整板偏位,多半是印刷机的 PCB 夹持或支撑出了偏差;如果是局部偏位,可能是钢网 MARK 与 PCB 的 MARK 匹配度不够。
锡珠在回流后出现在焊点周围或元件本体上。根源通常是印刷时焊膏被挤压到钢网背面或 PCB 非焊盘区域。排查重点:检查刮刀压力是否波动过大、钢网背面清洁是否彻底。钢网背面的残留是产生锡珠最常见的因素。
3D SPI:从 “检不检” 到 “怎么检” 再到 “怎么调”
2D SPI 只能看锡膏的平面面积和 X/Y 偏移,用 “有没有印上” 的标准来判断。但一旦涉及高度、体积和三维形貌,2D 就无能为力了。3D SPI 通过结构光投影或激光扫描,测量每块焊盘上焊膏的高度、体积、面积和偏移量,给出的是定量数据而不是简单的通过 / 不通过。
为了达到 “零缺陷” 交付,3D SPI 与 3D AOI 已成为精密SMT产线的标准配置。在实际应用中,3D SPI 最大的价值不是 “发现问题”,而是 “数据闭环”。印刷机印完一块板,SPI 立即检测每处焊盘的锡膏体积、高度和面积,一旦发现某个位置的锡膏体积出现系统性偏移,系统自动将补偿数据反馈给印刷机,由印刷机实时调整钢网对位或刮刀压力。
BGA 焊接缺陷的根源往往在印刷环节。X-Ray 检查发现的 BGA 内部空洞,很多是印刷时焊膏体积不足或形貌异常导致。3D SPI 能精准计算 BGA 焊盘上的焊膏体积,并通过 SPC 数据监控体积偏差是否超出工艺窗口。
在设置 CPK 基准时,我通常要求关键元件(BGA、QFN、细间距连接器)的焊膏体积 CPK 大于 1.33,达不到这个数值就说明工艺窗口太窄,需要从钢网设计或参数设置上找根本原因。
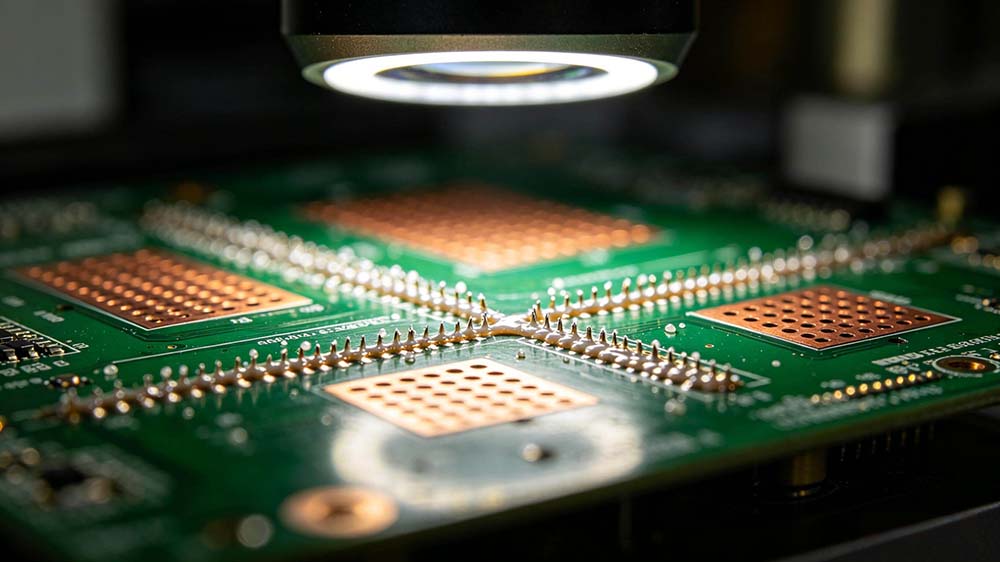
结语:印刷质量是一种系统能力
焊膏印刷不是调好一台机器就一劳永逸的事。它考验的是一个工厂在材料选型、钢网设计、参数调校、环境控制和检测反馈各个环节上的协同水平。焊膏的批次差异、车间温湿度的季节性波动、钢网张力的衰减、刮刀的磨损…… 任何一个变量失控,都会在印刷效果上体现出来。
好的焊膏印刷工艺,说到底就是建立一套能够提前发现偏差、及时修正的参数闭环机制。能够稳定交付高精度焊接板的工厂,靠的不是某个老师傅的经验,而是数据和标准构成的系统能力。了解更多详情欢迎联系爱彼电路技术团队