BGA工艺一显露出来,便变成IC封装的最佳挑选之一。进展直到现在,BGA封装工艺品类越来越多,不一样的品类具备不一样的独特的地方,工艺流程也不尽相同。同时,随同着BGA工艺和IC产业的进展,国产封测厂商渐渐登上历史戏台。
上百年90时代,BGA(Ball
grid array,球栅阵列或焊球阵列)封装技术进展迅疾并变成主流的封装工艺之一。它是一种高疏密程度外表装配封装技术,在封装底部,引脚都成球状并排列成一个大致相似于格子的图案,由此起名称为BGA。
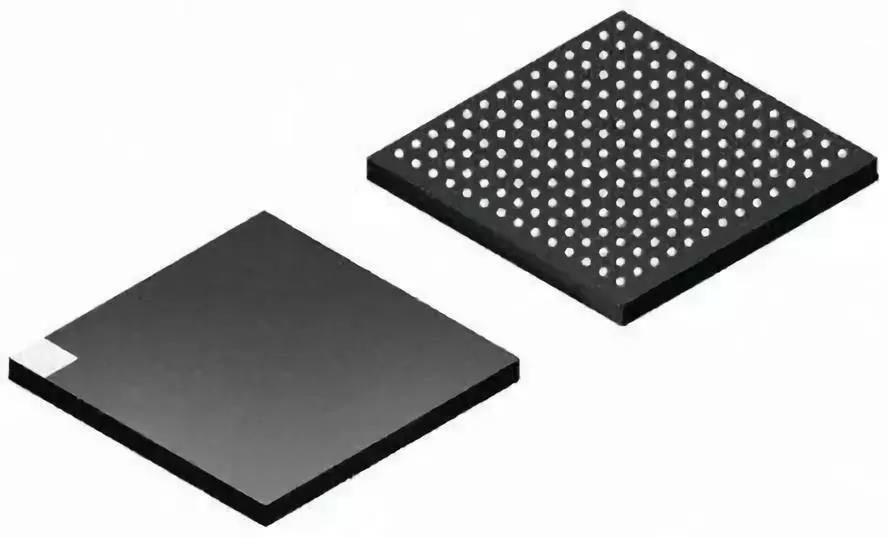
到现在为止主板扼制芯片组多认为合适而使用此类封装技术,材料多为瓷陶。认为合适而使用BGA技术封装的内存,可以使内存在大小未变的事情状况下,内存容积增长两到三倍。
本文主要内部实质意义为BGA封装的主要分类及其独特的地方,BGA封装工艺流程,以及国产封测厂商三方面。
1、BGA封装技术分类及独特的地方
BGA的封装类型众多,依据焊料球的排布形式可分为周边型、交叉型和全阵列型。

依据基板的不一样主要分为PBGA(Plastic BGA,塑封BGA)、CBGA(Ceramic BGA,,瓷陶BGA)、FCBGA(Filpchip BGA,倒装BGA)、TBGA(Tape BGA,载带BGA)。
PBGA封装
PBGA是最常用的BGA封装方式,认为合适而使用分子化合物塑料材料和分子化合物塑料工艺制造。其认为合适而使用的基板类型为PCB基板料料(变态天然树脂/玻璃层压板),裸芯片通过粘接和WB技术连署到基板顶部及引脚框架后,认为合适而使用注塑成型(环氧气膜塑混合物)办法成功实现群体塑模。Intel系列CPU中,Pentium II、III、IV处置器均认为合适而使用这种封装方式。
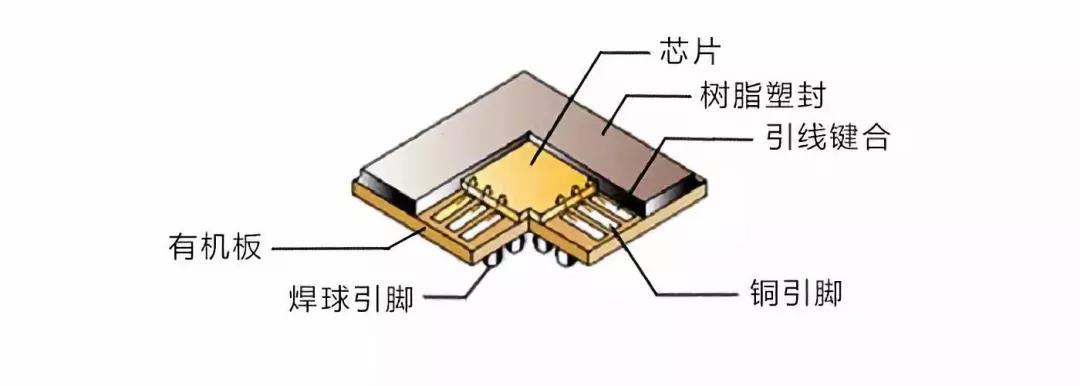
焊球材料为低熔点共晶焊料合金63Sn37Pb,直径约为1mm,间距范围1.27-2.54mm,焊球与封装体底部的连署不必额外运用焊料。组装时焊球熔化,与PCB外表焊板接拼凑,闪现桶状。

PBGA封装独特的地方主要表如今以下四方里面:
1.制造成本低,性价比高。 2.焊球参加再流焊点形成,共面度要求宽松。 3.与环氧气天然树脂基板热般配性好,装配至PCB时品质高,性能好。 4.对湿气敏锐,PoPCorn
effect
严重,靠得住性存在隐患,且封装高度之QFP高也是一技术挑战。 CBGA封装
CBGA是将裸芯片安装在瓷陶多层基板载体顶部外表形成的,金属盖板用严密封闭焊料烧焊在基板上,用以尽力照顾芯片、引线及焊盘,连署好的封装体通过气密性处置,可增长其靠得住性和物理尽力照顾性能。Pentium I、II、Pentium Pro处置器均认为合适而使用过这种封装方式。
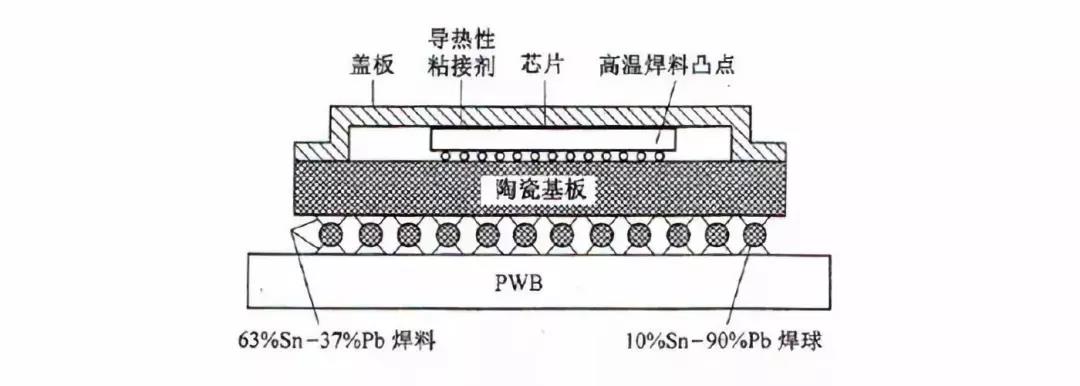
CBGA认为合适而使用的是多层瓷陶布线基板,焊球材料为高熔点90Pb10Sn共晶焊料,焊球和封装体的连署运用低温共晶焊料63Sn37Pb,认为合适而使用封盖+玻璃气封,归属气严密封闭装范畴。

CBGA封装独特的地方主要表如今以下六方面:
1.对潮气不聪明感,靠得住性好,电、热性能良好。
2.与瓷陶基板CTE般配性好。
3.连署芯片和元件可翻修性较好。
4.裸芯片认为合适而使用FCB技术,互连疏密程度更高。
5.封装成本较高。
6.与环氧气天然树脂等基板CTE般配性差。
FCBGA封装
FCBGA是到现在为止图形加速芯片最主要的封装款式,这种封装技术始于1960时代,当初IBM为了大型计算机的组装,而研发出了所说的的C4(Controlled Collapse Chip Connection)技术,随即进一步进展成可以利用熔化凸块的外表拉力来支撑芯片的重量及扼制凸块的高度,并变成倒装技术的趋势。
这种封装运用小球接替起初认为合适而使用的针来连署处置器。总共需求运用479个球,且直径均为0.78毫米,能供给最短的对外连署距离。FCBGA经过FCB技术与基板成功实现互连,与PBGA的差别就在于裸芯片面朝下。
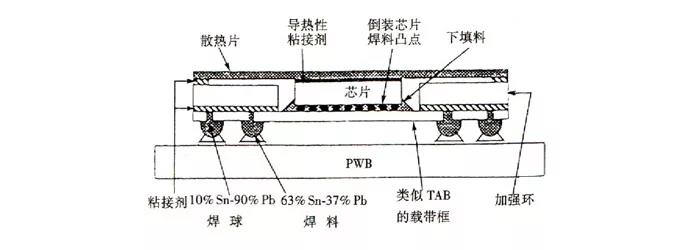
FCBGA封装独特的地方主要表如今以下三方面:
1.特别好的电性效能,同时可以减损组件互连间的伤耗及电感,减低电磁干扰的问题,并承担较高的频率。
2.增长I/O的疏密程度,增长运用速率,管用由大变小基板平面或物体表面的大小由大变小30百分之百至60百分之百。
3.散热性好,可增长芯片在高速运行时的牢稳性。
TBGA封装
TBGA又叫作阵列载带半自动键合,是一种相对较新而别致的BGA封装方式。其认为合适而使用的基板类型是PI多层布线基板,焊料球材料为高熔点焊料合金,烧焊时认为合适而使用低熔点焊料合金。
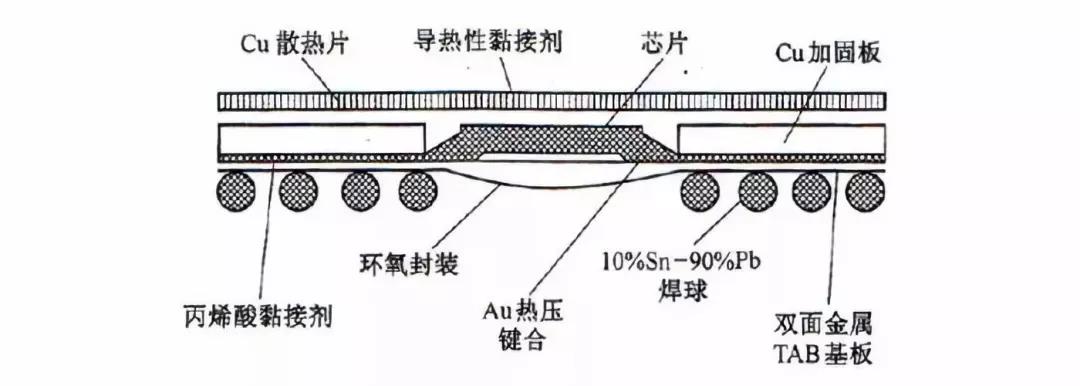
TBGA封装独特的地方主要表如今以下五方面:
1.与环氧气天然树脂PCB基板热般配性好。
2.最薄型BGA封装方式,有帮助于芯片薄型化。
3.相形于CBGA,成本较低。
4.对热度和湿润程度,较为敏锐。
5.芯片轻且小,相形其它BGA类型,自校准偏差大。
2、BGA封装工艺流程
到现在为止,很多芯片封装都为BGA型,这类封装的最大长处就是能节省板上面的天空间。最常见的是芯片上进结构,对热处置要求较高的畅达是运用腔向下的结构。大多数封装都认为合适而使用芯片键合技术将芯片与基板连署起来,并成功实现芯片与基板之间的电连署。BGA也这么,但更多是认为合适而使用倒装芯片互连技术。认为合适而使用倒装芯片预设可将散热片直接与芯片连署起来,达到更好散热的目标。
PBGA封装工艺流程
1.PBGA基板的制备
在变态天然树脂/玻璃芯板的两面压极薄(12-18um厚)的铜箔,而后行钻孔和通孔金属化,通孔普通位于基板的周围;再用常理的PWB工艺(压膜、暴光、显影、腐刻等)在基板的两面制造图形(导带、电极以及安装焊球的焊区阵列);最终形成媒介阻焊膜并制造图形,露出电极及焊区。
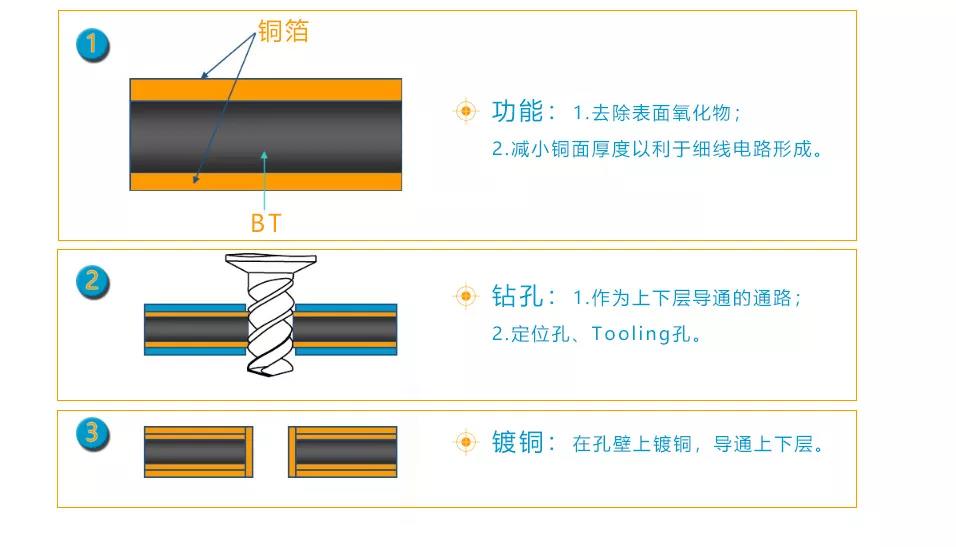
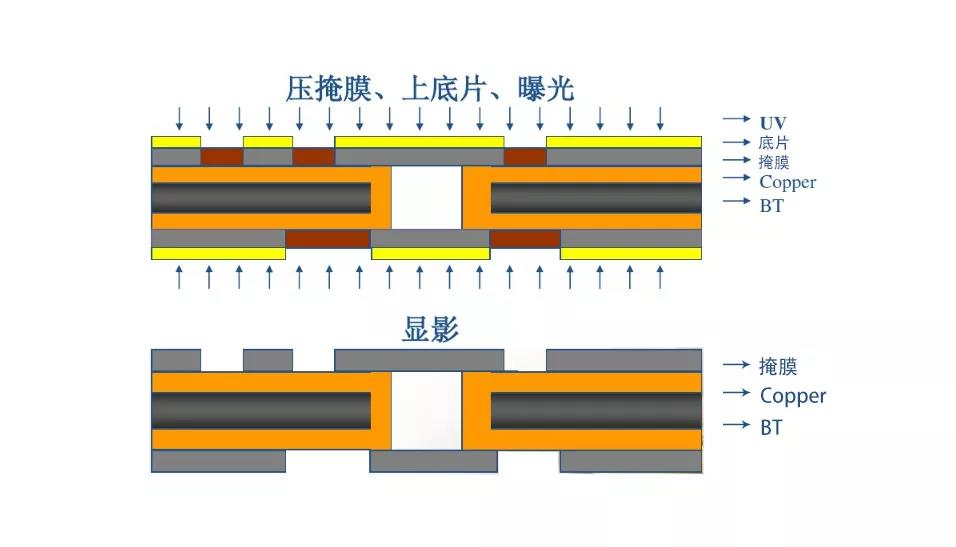

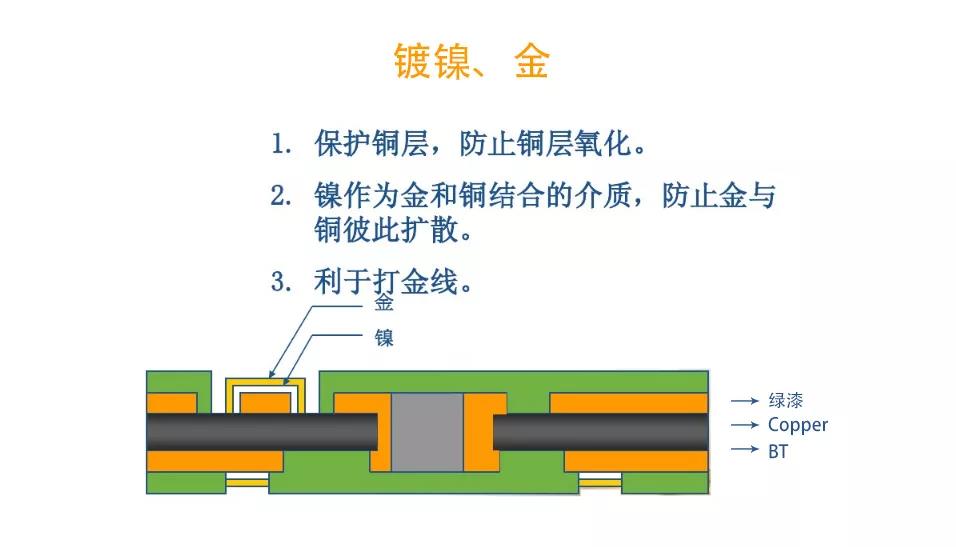
2.封装工艺流程
圆片减薄→圆片磨削→芯片粘结→清洗→引线键合→清洗→模塑封装→装配焊料球→回流焊→打标→离合→查缉及测试→包装
芯片粘结:认为合适而使用充银环氧气天然树脂粘结剂(导电胶)将IC芯片粘结在镀有Ni-Au薄层的基板上
引线键合:粘结固化后用金丝球焊机将IC芯片上的焊区与基板上的镀Ni-Au的焊区以金线衔接
模塑封装:用天有石英粉的环氧气天然树脂模塑施行模塑包封,以尽力照顾芯片、烧焊线及焊盘。
回流焊:固化在这以后,运用特设预设的吸拾工具(焊球半自动拾放机)将浸有焊药熔点为183℃、直径为30mil(0.75mm)的焊料球Sn62Pb36Ag2,还是Sn63Pb37安放在焊盘上,在传统的回流焊炉外在N2氛围下施行回流烧焊(无上加工温度不超过230℃),焊球与镀Ni-Au的基板焊区烧焊。
TBGA封装工艺流程
1.TBGA载带制造
TBGA载带是由聚酰亚胺PI材料制成的,在制造时,先在载带的两面覆铜,继续冲通孔和通孔金属化及制造出图形;而后镀镍、金,将带有金属化通孔和再散布图形的载带瓜分成单体。
封装热沉又是封装的加固体,也是管壳的芯腔基底,因为这个在封装前先要运用压敏粘结剂将载带粘结在热沉上。
TBGA适应于高I/O数应用的一种封装方式,I/O数可为200-1000,芯片的连署可以用倒装芯片再流,也可以用热压键合。
2.封装工艺流程
圆片减薄→圆片割切→芯片粘结→清洗→引线键合→等离子清洗→液态严密封闭剂灌封→装配焊料球→回流焊→打标→最后查缉→测试→包装
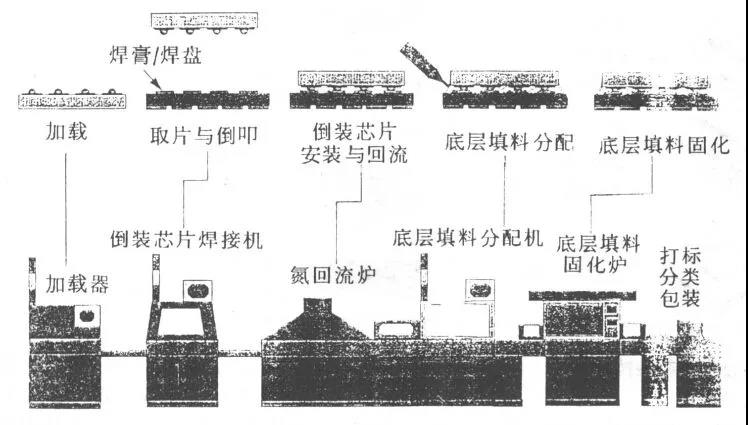
芯片粘结:全阵列型芯片,用C4工艺;周边型金凸点芯片,热压键合。
装配焊料球:用微焊技术把焊球(10Sn90Pb)烧焊到载带上,焊球的顶部熔进电镀通孔内,烧焊后用环氧气天然树脂将芯片包封。
FCBGA封装工艺流程
FCGBA基板制造是将多层瓷陶片高温共烧成多层瓷陶金属化基片,再在基片上制造多层金属布线,而后行电镀等。
2.封装工艺流程
圆片凸点的制备→圆片割切→芯片倒装及回流焊→底部补充→热传导脂、严密封闭焊料的分配→封盖→装配焊料球→回流焊→打标→离合最后查缉→测试→包封
倒装烧焊:克服了引线键合焊盘核心距极限的问题,在芯片的电源/地线散布预设上供给了更多便利,为高频率、大功率部件供给更完备的信号。
基板挑选:关键因素在于材料的热体胀系数(CTE)、介电常数、媒介伤耗、电阻率和热传导率等。
凸点技术:常用的凸点材料为金凸点,95Pb5Sn、90Pb10Sn焊料球(回流焊温度约为350℃)。技术的关键在于当节距由大变小时,务必维持凸点尺寸的牢稳性。焊料凸点尺寸的完全一样性及其共面性对倒装焊的符合标准率有莫大的影响。
CBGA封装工艺流程
相形于PBGA和TBGA,CBGA有点许不一样,主要表如今三个方面:
1.CBGA的基板是多层瓷陶布线基板,PBGA的基板是变态多层布线基板,TBGA基板是增强环的聚酰亚胺(PI)多层Cu布线基板。
2.CBGA基板下边的焊球为90百分之百Pb-10Sn百分之百或95百分之百Pb-5Sn百分之百的高温焊球,而与基板和PWB烧焊的焊料则为37百分之百Pb-63Sn百分之百的共晶低温焊球
3.CBGA的封盖为瓷陶,使之变成气密性封装;而PBGA和TBGA则为分子化合物塑料封装,非气密性封装。