半导体是指在常温下电导性能介于导体和绝缘体之间的材料。半导体应用于集成电路、消费电子、通讯系统、光伏发电、照明、大功率电源转换等领域。例如,二极管就是由半导体制成的器件。半导体生产过程如下:包括晶圆制造、晶圆测试、芯片封装和封装后测试。半导体封装测试是指根据产品型号和功能要求对被测晶圆进行加工获得独立芯片的过程。

1. 半导体封装测评介绍
半导体是指在常温下电导性能介于导体和绝缘体之间的材料。半导体应用于集成电路、消费电子、通讯系统、光伏发电、照明、大功率电源转换等领域。例如,二极管是由半导体制成的器件。半导体生产过程如下:包括晶圆制造、晶圆测试、芯片封装和封装后测试。半导体封装测试是指根据产品型号和功能要求对被测晶圆进行加工获得独立芯片的过程。
随着技术的发展,半导体芯片晶体管的密度越来越高,相关产品的复杂度和集成度呈指数级增长。这对芯片设计和开发来说是前所未有的挑战。另一方面,随着芯片开发周期的缩短,流片成功率非常高,任何失败都是企业难以承受的。为此,在芯片设计开发过程中,需要进行充分的验证和测试。此外,半导体制程技术的不断提升,需要大量的技术挑战,测试变得更加重要。那么,半导体封装评估会用到哪些设备呢?

2. 半导体封装评估设备
(1) 减薄机
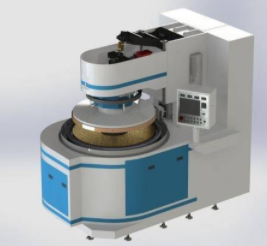
由于制造工艺的要求,对晶圆的尺寸精度、几何精度、表面清洁度和表面微晶格结构提出了很高的要求。因此,在数百个工艺流程中,只能使用一定厚度的晶圆进行转移和流片。通常,在集成电路封装前,需要将芯片背面多余的基材去除至一定厚度。这个过程称为晶圆背面减薄工艺,对应的设备是晶圆减薄机。减薄机通过减薄/研磨对晶圆基板进行减薄,以提高芯片的散热效果。减薄到一定的厚度有利于后期的封装工艺。
(2) 四探针

测量不透明薄膜的厚度。由于不透明薄膜无法利用光学原理进行测量,因此采用四探针仪器测量薄层电阻,根据薄膜厚度与薄层电阻的关系间接测量薄膜厚度。方形电阻可以理解为硅片上方形薄膜两端之间的电阻。它与薄膜的电阻率和厚度有关,与方形薄膜的大小无关。四探针使四个探针等距放置在一条直线上依次接触硅片,在外侧的两个探针之间施加已知电流,同时测量内侧的两个探针之间的电位差,从而可以得到薄层电阻值。