MEMS器件体积小,造价低,是未来传感器的发展方向,随着MEMS技术进步,惯性MEMS传感器、中等角频率传感器分辨率高且低成本的惯性组件, 用于测量导弹姿态的偏航角和旋转滚动速率。MEMS器件中,封装技术极为重要性,坚固耐用的惯性MEMS器件,除集成技术外封装成为另一个核心,我们对封装技术进行探讨研究,旨在提高MEMS器件的可靠性。
MEMS器件封装技术顺势而生,它的制备工艺和设备已相当成熟,MEMS器件的应用并不多,没有大范围进行推广。因为MEMS器件的封装技术没有达到很高的水准,所封装的器件并没很好的质量。MEMS器件封装技术的不成熟在很大程度上面限制MEMS商业的发展。
1 MEMS概述
MEMS又称微机电系统,是比较独立的智能系统,尺寸很小,只有几毫米甚至更小,由三大部分组成,传感器、动作器和微能源。MEMS 设计包含多方面学科,主要是物理学、化学、材料工程、电子工程等一系列学科,微机电系统应用于多方面领域,汽车电子领域、计算机领域、消费电子领域、网络通信类这四类是最常见的领域。MEMS 工艺与传统的IC工艺有许多相似之处,MEMS 借鉴了IC 工艺,如光刻、薄膜沉积、掺杂、刻蚀、化学机械抛光工艺等,对于毫米甚至纳米级别的加工技术,传统的IC 工艺是无法实现的,必须得依靠微加工,进行精细的加工,能达到想要的结构和功能。微加工技术包括硅的体微加工技术、表面微加工技术。体加工技术是指沿着硅衬底的厚度方向对硅衬底进行刻蚀的工艺,是实现三维结构的重要方法。表面微加工是采用薄膜沉积、光刻以及刻蚀工艺,通过在牺牲层薄膜上沉积结构层薄膜,然后去除牺牲层释放结构层实现可动结构。
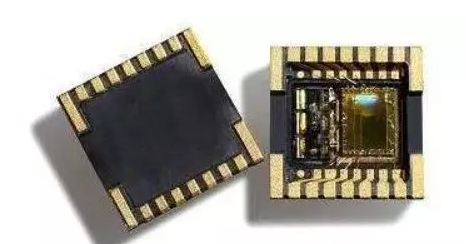
2 MEMS器件封装优势
微机电系统是按照功能在芯片上的集成,尺寸一般是在毫米以下,制作工艺更加精密,需要更高的技术,微机电系统早在国外就有应用,我国起步晚,在MEMS 方面的投入逐渐增大,所占市场股份越来越大。微机电系统的出现和发展是现代科学创新思维的结果,也是微观尺度制造技术方面的进化和革命。MEMS在传感器领域应用的最为广泛,因为体积小,重量轻,成本低价的原因广受欢迎,使多种领域对体积小性能高的MEMS产品的需求迅速增长,在消费电子、医疗等领域就发现了大量的MEMS产品。MEMS有如下五个特点:
2.1 微型化
MEMS 器件总的来说就是“小”,不管是在体积,重量,还是在耗能,造价方面都是属于“微型”系列,并且工作效率高,响应的时间短。
2.2 材料来源广,性能优秀
大部分集成电路和MEMS的原材料是硅,硅可以从二氧化硅中经过化学反应对其进行提炼,二氧化硅是砂子的主要成分,原材料随处可见。此外,硅的硬度与铁相当,密度小,与铝类似,热传导性强。
2.3 批量生产
完整的MEMS在一片硅片上面同时被制造,大片的生产能够提高生产效率,也节约了大量的成本。
2.4 集成化
由各种功能不同的传感器或者执行器组成的系统,形成微执行器阵、微传感器阵列,还能把功能多样的器件组合起来,构成繁杂的微系统。微执行器、传感器和微电子器件的合成创造出的MEMS可靠性和稳定性都比较高。
2.5 多学科交叉
MEMS设计知识广泛,多学科知识相交,MEMS技术变得异常复杂,涉及各方面知识, MEMS器件借鉴了很多现代科学技术发展成果。
3 MEMS器件封装技术
3.1 倒装焊技术
倒装焊是将芯片的正面朝下,然后和封装基板一起进行封装。这样的好处体现在,芯片与基板直接连接,硅片就能够直接倒扣在PCB上,再从硅片的周围引出I/O。周围直接引出I/O,不需要再从一个接口上面连接,大大缩短了互联的长度,进而减小了延迟,提高了运行速度,达到最终目的提高电能性。很明显,对于这种连接方式,能够最大程度上面利用空间,并且不会因为连线过多而导致体积过大,相反的,倒装的效果和原芯片的大小几乎相同,大大提高了运行效率。在所有表面安装技术中,倒装芯片可以达到最小、最薄的封装,使整个封装之后的器件体积缩小不少。因为凸点能够充满整个管芯,I/O的互连密度也大大增加,加快了输入输出的效率,又因连线缩短,缩短了信号传输时间,进而大大改善了电性能。如在微麦克风中就应用了此技术,为了使信号串扰和引线电感有所减少,需要缩短放大器和麦克风之间的引线。为了达到该目的,微麦克风MEMS芯片和放大电路需要被封装在一起,这样的器件封装需要采用倒装焊技术,减小封装体积还能支持一些其他用途。经过MEMS器件封装之后的微麦克风具有低功耗,高灵敏度的特点,很大程度上提高了麦克风的效果,与传统的驻极体麦克风,价格上便宜了很多。
3.2 多芯片组件技术
多芯片组件(MCM)属于系统级封装,是电子封装技术层面的大突破。MCM是指一个封装体中包含通过基板互连起来,共同构成整个系统的封装形式的两个或两个以上的芯片。并为组件中的所有芯片提供信号互连、I/O管理、热控制、机械支撑和环境保护等条件。
3.3 多芯片封装
多芯片封装是MEMS封装的另一发展趋势。压缩整个器件的体积、适应小型化、缩短信号到执行器之间的距离、减小信号和外界干扰所带来的各种影响,将其MEMS芯片与信号处理芯片安放于同一管壳内。在用陶瓷的基板的基础上,用引线键合技术将传感器安装在一起,将基板封装,最后就顺利完成了MEMS的封装。
MCM提供了一种特有的可以在同衬底上同时支持多种芯片的能力的诱人的集成和封装MEMS器件的途径,无需改变MEMS和电路的制造技术,其性能还可以无妥协地做出优化。以MCM技术为基础的MEMS封装代替传统的单芯片封装结构完全没问题,还将其器件的性能和可靠性显著提高了。例如山西科泰公司生产的将控制电路和MEMS芯片装在一个基板上的加速度传感器的封装,利用这种封装技术,用便捷的方法提高了封装的可靠性及其封装密度,同时提高生产效率和批量生产的速率。从各种技术优势来看,完成MEMS芯片和基板的互连是可行的。
4 结语
MEMS封装技术的发展,借鉴IC封装经验,降低生产成本;在芯片结构设计初期,利用建模的思想来进行模拟封装,寻找适合的材料和工艺。MEMS封装技术的发展,工艺程序只会越来越来复杂,越来越多样化,加快MEMS封装技术的研究步伐,提供优质的产品。