受电子产品的小、轻、薄的驱动,封装领域也是不断开发出新的封装type。CSP封装就是比较革命性的产品,Size是裸芯片的1.2倍甚至同等大小,尤其随着移动电子的兴起,这种裸芯片封装(Wafer Level CSP)封装已经是最小最省钱的封装方式了,虽然前期需要RDL的光罩费用,但是它省去了Leadframe的费用,直接solder bump焊接到主板上即可。
CSP(Chip-Scale or Chipe-Size Package)的concept起源于1990s,follow的是IPC/JEDEC J-STD-012标准,它主要应用于Low pin count的EEPROMs、ASICs 以及microprocessors (MCU)等,尤其当Wafer越大而Die又越小的时候,其成本会更有优势。
CSP封装主要的步骤为: 把die mount到epoxy interposer上,再用wire bond (gold or Al)将PAD和基板连接起来,第三步用Molding Plastic封装保护Die和Wire,最后再将Solder ball贴到Interposer底部。
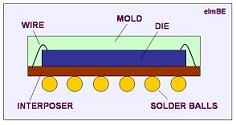
当然上面的wire bond会让封装比起die size还要大一点。而且从die到lead frame上的导线还有连接阻抗的,后来发展到用bump代替wire bond,所以就发展到Flip chip代替Wire bond封装,这样就节省了wire bond的空间了,所以就可以做到Die几乎等size的package了。
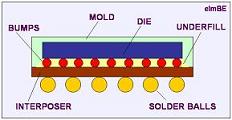
那说到倒片封装(FC: Flip-Chip),自然就要讲到这个bump了,不可能把die切割了再去长这个bump吧,所以必须在Wafer还没切割之前就做完这个process,所以就叫做Wafer Level CSP封装了 (WLCSP)。
Flip-Chip封装主要的三个步骤,Die上长bumps,脸朝下把长好球的die贴倒贴到衬底或者基板上,然后填充(underfilling)。
WLCSP现在已经是封装技术的主流,主要有两种,一种是直接BOP (Bump On Pad),还有一种是RDL (Redistribution Layer)。BOP技术还需要根据是否需要Polymer做re-passivation,再分为BON(Bump on SiN)和BOR (Bump on Repassivation)。BOP广泛应用于Analog/Power封装,它由于电流是直接垂直流过,没有横向RDL,所以对于功率器件封装很有优势,Cost也很低,但是它的Pin count比较有限,所以才发展到RDL+Bump。BOP是直接把UBM/Bump锚在Top Metal的PAD上,而RDL+Bump是用Polymer (Polyimide或PBO) 隔离并布线并且把Bump与device surface隔开。
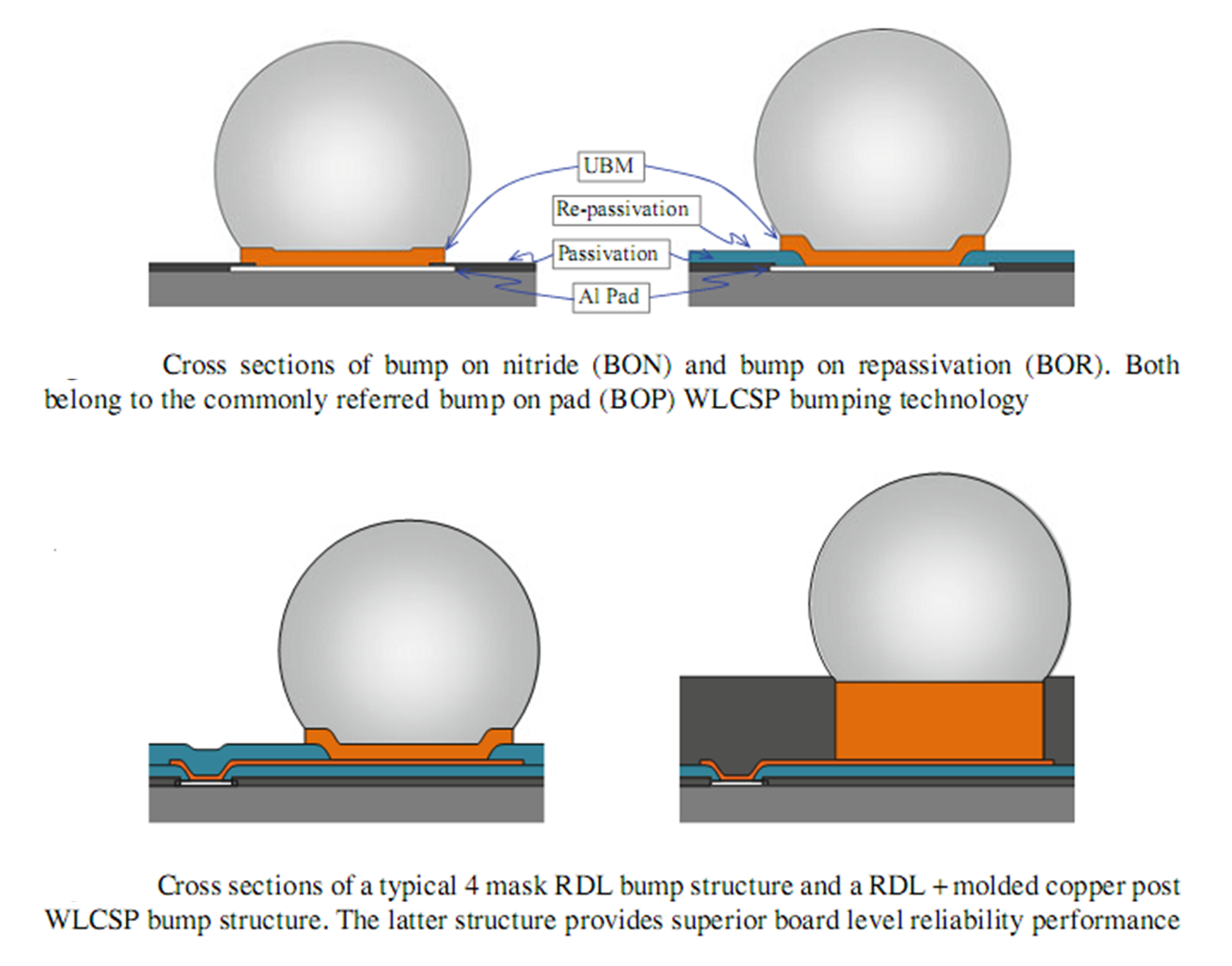
再简单讲一下RDL+Bump+铜柱的工艺流程吧,和FAB工艺差不多吧,四层光罩即可。RDL之间的dielectric用Polyimide隔离。Metal可以用电镀长上去(Seed用Sputter)。
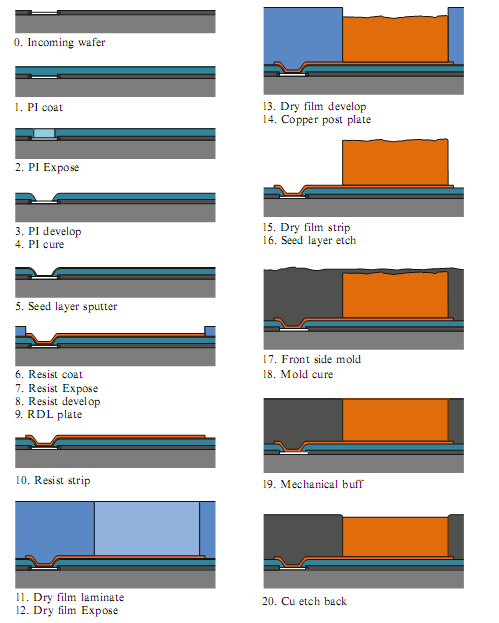
成型之后的RDL+Bump就是如下图的样子:
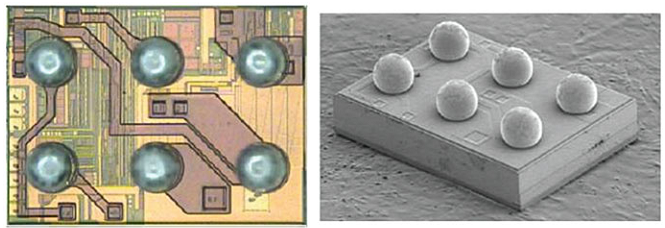
最早的WLCSP是Fan-In的,意思就是bump全部长在die上,而die和Pad的连接主要就是靠RDL的Metal Line来连接的。与之对应的就是Fan-Out的WLCSP封装,这就是把bump长到chip外面去了 (1.2倍),面积大点,bump的压力不会对芯片造成损伤。
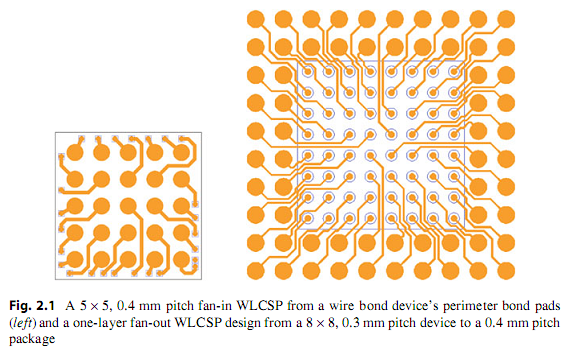
讲solder ball之前,还是总结一下Flip-Chip和WLCSP之间到底区别是什么?Flip-chip一般还是需要衬底的,只是它通过solder ball倒装贴上去的(代替Wire bond)而已,而WLCSP是把长好的球做好之后直接贴到PCB板上去。
好了,不管是Flip-Chip还是WLCSP都需要一个东西叫做Solder Ball (锡球),那接下来该讲解Solder Ball了,这些Bump是怎么长上去的。
先讲讲为啥用锡球?那就要回答一个问题,Solder Ball的技术要求是什么?
1) Fully Freflowable:类似焊锡熔融才能连接,那焊锡的要求就是加热不能随意流动,必须往中间聚拢(Self-Center),而且易坍塌(Collapse),这就是焊锡的特点。
2) 可控的Alloy成分: 一般用10~15%的锡铅合金(63Sn/Pb)能提高液态温度到200~215C。
3) 能兼容各种Alloy要求: 比如共晶Sn/Pb (Eutectic),High Pb,以及Sony Green提出的Pb-Free等各种Alloy来适应市场要求。
4) 能控制Bump高度确保良率,厚度deviation<2.5um。
锡球的大小一般是150um, Pitch约0.5mm。也有uBump尺寸在75~130um,也有用300~500um的。一般Solder Ball Bump成分是锡铅共晶(Sn63Pb37),但是现在环境污染的要求(RoHS)推出无铅锡球等,但不管怎么变技术上重点是组装回流焊的温度曲线必须满足特定温度上保持一段时间(thermal budget)稳定。
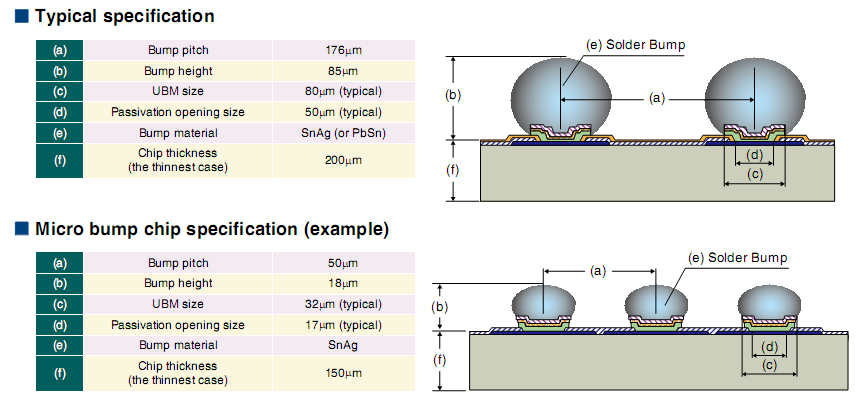
锡球工艺一般采取的工艺有: 蒸发(Evaporation)、电镀(Electroplating)、印刷(Screen printing)、或针孔沉积(Needle depositing)等,但是Solder ball不是直接与Pad Metal连接的,类似FAB的Metal一样,必须要有Adhesion和Barrier Layer,而这层过渡的Metal就是UBM (Under Bump Metallization),作用当然就是Adhesion和Barrier了,而且要求必须接触电阻低。而这个UBM通常采用Sputter或电镀的方式都可以实现。最后用常用的电镀法讲述锡球形成的过程(最后一步Bump Shaping是通过第六步的形状回流后包裹成型的)。
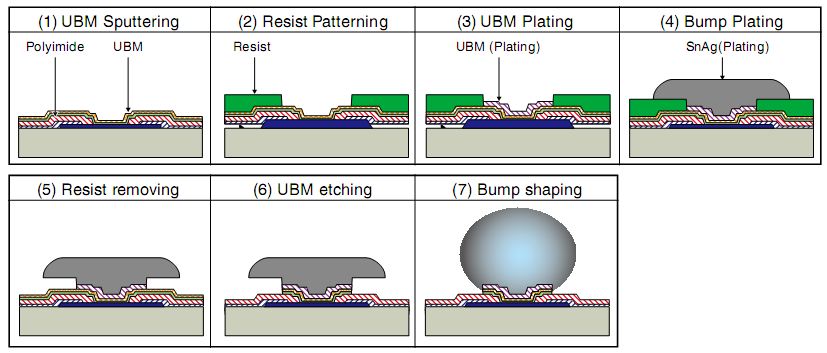
好了,至此就讲完了WLCSP和Flip-chip了(技术细节请参阅《Wafer-Level Chip-Scale Packaging》--Shichun Qu, Yong Liu, Springer Science),这也是现在中低端消费类市场的主流封装模式了,高端市场当然就是SiP的3D封装了,再开一篇吧。敬请期待!
